Автоэмиссионный сканирующий электронный микроскоп Шоттки JSM-7800F
СНЯТО
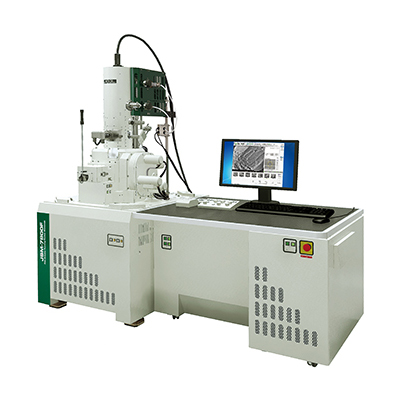
Особенности
Недавно разработанный супергибридный объектив (SHL) используется для достижения высокого разрешения РЭМ следующего поколения без ущерба для удобства работы. Использование электронной пушки типа Шоттки обеспечивает стабильный анализ при большом токе зонда.
Наблюдение с высоким разрешением с использованием супергибридного объектива (SHL)
Линза объектива представляет собой супергибридную линзу (SHL), состоящую из электростатического магнитного поля, наложенного на электростатическое электрическое поле. Уменьшение хроматических и сферических аберраций улучшает разрешение, особенно при низких ускоряющих напряжениях. SHL не оказывает влияния магнитного поля на образец, поэтому наблюдения магнитных материалов и анализ EBSD могут быть выполнены без труда.
Отбор энергии при низких ускоряющих напряжениях
Энергетический фильтр установлен непосредственно под верхним детектором электронов (ВЭД), поэтому возможен выбор энергии. Вторичные электроны и обратно рассеянные электроны могут быть точно выбраны даже при низких ускоряющих напряжениях, что позволяет наблюдать за составом верхней поверхности образца с использованием изображения обратно рассеянных электронов при низких ускоряющих напряжениях.
Визуализация верхней поверхности с помощью Gentle Beam
При подаче напряжения смещения на образец (GB) скорость падающих электронов уменьшается, а скорость высвобождаемых электронов увеличивается. Это позволяет получать изображения с высоким разрешением и хорошим соотношением сигнал/шум даже при низкой энергии воздействия на образец. Если используется режим GB, который позволяет прикладывать более высокое напряжение смещения, можно проводить наблюдения с еще более высоким разрешением даже при энергии воздействия на образец всего в несколько десятков эВ.
Сбор всей информации с помощью нескольких детекторов
JSM-7800F включает в себя 4 типа детекторов, включая детектор верхних электронов (UED), детектор верхних вторичных электронов (USD), детектор обратно рассеянных электронов (BED) и детектор нижних электронов (LED). Для UED дозу вторичных электронов и обратно рассеянных электронов можно изменять в соответствии с напряжением фильтра, что позволяет выбирать энергию электронов. USD обнаруживает низкоэнергетические электроны, которые отскакивают от фильтра. С помощью BED можно четко наблюдать канальный контраст, обнаруживая обратно рассеянные под малым углом электроны. Светодиод позволяет получать изображения с трехмерным видом, включая информацию о шероховатости поверхности от эффектов освещения.
примеры применения
Наблюдение при низком ускоряющем напряжении
Методом мягкого луча (GB) возможно наблюдение при энергии воздействия на образец 10 эВ. Поверхность листа графена толщиной всего в один атом видна при энергии воздействия на образец 80 эВ.

Образец: графен (энергия воздействия образца: 80 эВ)
Выбор энергии
Когда изображение BE (слева) и изображение SE (справа) одновременно получают с помощью UED и USD, возможна точная интерпретация изображений. Сегрегация между частицами золота и TiO2, не очевидный на SE-изображении, контрастность которого зависит в основном от топографии, становится отчетливым на BE-изображении, где частицы золота становятся ярче из-за его более высокого среднего атомного номера.

БЫТЬ образ
Образец: катализатор TiO2 на золотом носителе (2 кВ)

SE изображение
Наблюдение с помощью ГБШ
В методе GBSH к образцу прикладывается отрицательное напряжение. Благодаря уменьшению аберрации получаются изображения с высоким разрешением. Реализовано четкое наблюдение мезопористого кремнезема.

Образец: мезопористый кремнезем (энергия воздействия на образец: 1 кэВ)
Наблюдение за магнитными материалами
ШЛ не создает магнитного поля вокруг образца. Поэтому наблюдение магнитных материалов с высоким разрешением и даже при низкой энергии воздействия на образец может быть выполнено без труда.

Образец: наночастицы магнетита (энергия воздействия на образец: 1 кэВ)
EBSD удобно проводить, так как SHL не оказывает влияния магнитного поля на образец. IPF Map производит высокоточный анализ ориентации кристаллов.

Количество баллов: 118585
Габаритные размеры:
X Макс: 80.00 микрон, Y Макс: 79.89 микрон
Шаг: 0.25 микрон
Фазы: Nd2Fe14B

Пример шаблона EBSD

ND

TD

RD

Характеристики
| Постановления | 0.8 нм (15 кВ) 1.2 нм (1 кВ) 3.0 нм (15 кВ, 5 нА, WD10 мм) |
|---|---|
| Увеличение | От ×25 до ×1,000,000 XNUMX XNUMX (SEM) |
| Ускоряющее напряжение | 0.1kV - 30kV |
| Ток зонда | От нескольких пА до 200 нА |
| Объектив с оптимизацией угла диафрагмы | Встроенный |
| Детекторы | Детектор верхних электронов (UED) Нижний детектор электронов (светодиод) |
| Энергетический фильтр | Встроенная функция изменения напряжения фильтра UED |
| Нежный луч | Встроенный |
| Отображение изображения | Область отображения изображения 1,280 x 960 пикселей, 800 x 600 пикселей |
| Камера обмена образцами | Стандарт Состав камеры обмена образцами TYPE2A. |
| Стадия образца | 5-осевой моторный столик Полная эвцентрическая ступень гониометра |
| XY | Х: 70 мм, Y: 50 мм |
| Наклон | от -5 до +70° |
| Вращение | 360° |
| WD | 2mm к 25mm |
| Система эвакуации | Два SIP, TMP, RP |
| Эко дизайн | При нормальной работе: 1.1 кВА В спящем режиме: 0.8 кВА |
Основные параметры
Энергодисперсионный рентгеновский спектрометр (EDS)
Волнодисперсионный рентгеновский спектрометр (WDS)
Система дифракции обратного рассеяния электронов (EBSD)
Детектор катодолюминесценции (CLD)
Приложения
Приложение JSM-7800F
Сравнение методов трехмерной визуализации в электронной микроскопии биоматериалов
Применение сканирующего электронного микроскопа для визуализации дислокаций в стали
Электроны, рассеянные назад под большим углом, и электроны, рассеянные назад под малым углом
Быстрая характеристика бактерий с помощью ClairScope и SpiralTOF
Фото
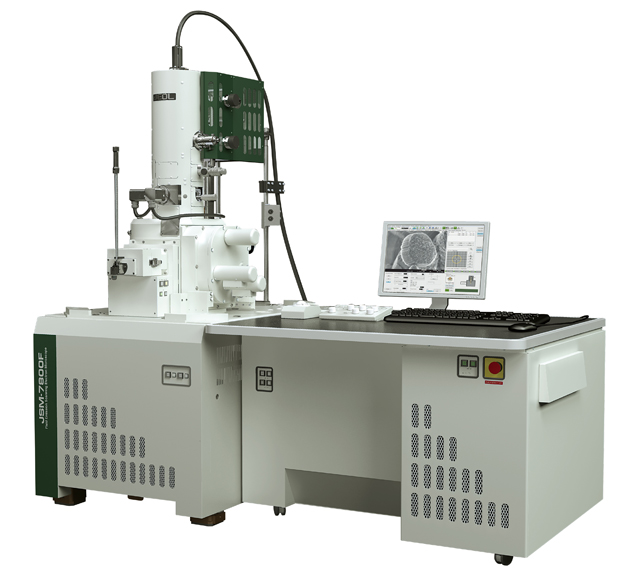
Связанные товары

Система miXcroscopy™ для оптической и сканирующей электронной микроскопии
Теперь один и тот же держатель образца можно использовать как для оптического микроскопа, так и для сканирующего электронного микроскопа. В результате, управляя информацией об столике с помощью специального программного обеспечения, система может записывать места, наблюдаемые с помощью оптического микроскопа, а затем дополнительно увеличивать те же области с помощью сканирующего электронного микроскопа, чтобы наблюдать тонкие структуры при большем увеличении. более высокое разрешение. Цели наблюдения, обнаруженные с помощью оптического микроскопа, можно беспрепятственно наблюдать с помощью сканирующего электронного микроскопа без необходимости повторного поиска цели. Теперь можно плавно и легко сравнивать и проверять изображения оптического микроскопа и изображения сканирующего электронного микроскопа.

Серийный блочный СЭМ JSM-7200F・7800F / Gatan 3View®2XP
3View®2XP (Gatan Inc.) встроен в сканирующий электронный микроскоп Шоттки с полевой эмиссией, который может производить тонкие электронные зонды при сильном токе в течение длительных периодов времени, позволяя автоматически создавать поперечные сечения образца и получать изображения. Трехмерная реконструкция полученных изображений позволяет проводить детальный анализ тонких структур в трех измерениях.
Подробнее
Вы медицинский работник или персонал, занимающийся медицинским обслуживанием?
Нет
Напоминаем, что эти страницы не предназначены для предоставления широкой публике информации о продуктах.


