Структурный анализ полупроводниковых приборов с использованием томографии STEM/EDS
НОВОСТИ JEOL, том 53, № 7
Ёситака Аояма1, Ичиро Ониши1, Нориаки Эндо1, Эйдзи Окуниси1, Такео Сасаки2, Ёринобу Ивасава3, Юкихито Кондо1
1Бизнес-подразделение EM, JEOL Ltd. 2ДЖЕЛ (Великобритания) ЛТД. 3Бизнес-подразделение ЕС, JEOL Ltd.
В последнее время полупроводниковые устройства разрабатываются как трехмерная архитектура стекирования для обеспечения высокой производительности и высокой степени интеграции. Таким образом, трехмерный структурный анализ полупроводниковых устройств с нанометровым разрешением важен для улучшения полупроводниковых устройств. EDS-томография становится популярной для характеристики образцов, имеющих трехмерную структуру, таких как полупроводниковые устройства или металлические материалы, поскольку этот метод позволяет нам увидеть трехмерное распределение атомных частиц в образцах. Необходимо повысить чувствительность обнаружения рентгеновских лучей, так как сигналы характеристического рентгеновского излучения обычно слабы. Для получения большего количества рентгеновских сигналов от образцов была разработана система детектирования рентгеновского излучения с двумя детекторами ЭДС. В системе детекторы расположены симметрично относительно оси наклона держателя образца. Таким образом, некоторая часть генерируемого рентгеновского излучения блокируется держателем образца или поддерживающей решеткой (сеткой) в определенном диапазоне углов наклона. Затенение в этой конфигурации может вызвать артефакты в результирующих трехмерных картах элементов. Недавно мы разработали новую систему обнаружения ЭДС, детектор которой размещается на оси наклона предметного столика для получения томограмм ЭДС без затенения. Система была установлена в ТЭМ 3 кВ. Томограммы ЭДС образца пленки краски получали с помощью детектора ЭДС. Интенсивность каждой карты Ti Kα была почти постоянной в диапазоне наклона образца. Отмечено, что установленный на новом месте детектор ЭДС практически не блокировал рентгеновское излучение от держателя и сетки образца. Трехмерные карты элементов FinFET, одного из современных полупроводниковых устройств, были успешно получены с использованием новой конфигурации детектора EDS.
Введение
Полупроводниковые приборы широко используются в электронной продукции во всем мире. Исторически сложилось так, что полупроводниковые устройства с высокой плотностью интеграции были реализованы за счет уменьшения размера транзисторов на кристалле. В последнее время полупроводниковые устройства разрабатываются как трехмерная (3D) архитектура стекирования для высокой интеграции и производительности [1-2]. Трехмерное наблюдение с нанометровым разрешением необходимо для разработки и анализа отказов новых устройств [3-3]. Электронная томография (ЭТ) — это один из методов получения трехмерной структуры образцов с наномасштабным трехмерным разрешением с использованием просвечивающей электронной микроскопии (ПЭМ). EDS-томография выполняется в сочетании с энергодисперсионной рентгеновской спектроскопией (EDS) и ET для реализации трехмерной химической характеристики на основе наборов двумерных карт серии наклонов элементов, полученных с помощью TEM, оснащенного детекторами EDS [4-3]. Этот метод применяется к новым полупроводниковым устройствам и металлическим материалам для наблюдения этих трехмерных структур [3-3]. Когда в 2 году был получен первый результат томографии EDS, детекторы EDS кремниево-литиевого типа, которые имели низкую скорость аналитического счета, обычно использовались для получения карты EDS с высокой дозой электронов и длительным временем сбора данных. Таким образом, томография EDS не была полезна для трехмерного элементного анализа из-за повреждения луча облучения и загрязнения образцов. Но недавно были разработаны крупногабаритные кремниевые дрейфовые детекторы (СДД) и система множественного обнаружения ЭДС для ТЭМ [5]. При использовании новой системы SDD карты EDS можно получить примерно в 6 раз быстрее, чем при использовании предыдущей системы обнаружения кремний-литиевого типа [3]. Томограммы ЭДС твердых материалов стало легко получать с помощью двойной системы SDD, хотя по-прежнему сложно получить томограммы ЭДС чувствительных к лучу материалов, таких как биологические образцы.
EDS-томография является мощным инструментом для качественного анализа трехмерной элементной структуры, но EDS-томография имеет два вида ограничений для трехмерного количественного анализа, вызванных относительным расположением образцов TEM и детекторов EDS [3]. На рисунке 3 (а) показан эффект поглощения, который является ограничением для количественного анализа в томографии EDS. Черные стрелки указывают пути рентгеновских лучей, генерируемых падающими электронами. Когда структура образца симметрична, общее количество генерируемого рентгеновского излучения с ближней и дальней сторон детекторов ЭДС одинаково. Однако генерируемое рентгеновское излучение с дальней стороны может быть поглощено самим образцом. В результате регистрируемое рентгеновское излучение с дальней стороны меньше, чем с ближней. Эффект поглощения может вызывать артефакты в результирующей 14D-карте элементов. В недавнем исследовании была предпринята попытка компенсировать эффект самопоглощения путем расчета полученных томограмм ЭДС [1]. На рис. 3(b) показано еще одно ограничение — эффект затенения. Обычно образцы для ТЭМ закреплялись на сетке, а сама сетка закреплялась на держателе образца. Когда два детектора EDS расположены симметрично относительно оси наклона держателя образца в предыдущей системе EDS, часть генерируемого рентгеновского излучения блокируется сеткой или держателем образца в определенном диапазоне углов наклона. Затенение в этой конфигурации также может вызвать артефакты в результирующей 15D-карте элементов. Чтобы избежать этого эффекта затенения, необходимо скорректировать измеренную интенсивность карты EDS после получения в соответствии с ожидаемой или предварительно измеренной эффективностью обнаружения. Для трехмерного количественного анализа из томограмм EDS необходимо удалить как эффект поглощения, так и эффект затенения.
Предыдущая конфигурация ЭДС-детектора показана на рис. 2(а). Детекторы EDS расположены по обеим сторонам оси наклона. В этой конфигурации телесные углы SDD изменяются в зависимости от угла наклона. Мы улучшили этот вариант новой конфигурацией детектора EDS, в которой SDD размещен на оси наклона (рис. 2 (b)). Ожидалось, что SDD на оси наклона не оказывает эффекта затенения во всем диапазоне углов наклона для томографии EDS. Целью данного исследования является прояснение того, что новая конфигурация детектора EDS не имеет эффекта затенения в томографии EDS, а также получение трехмерных количественных карт элементов от полупроводниковых устройств.
Рис.1 Схематические диаграммы двух ограничений для трехмерного количественного анализа в томографии EDS.
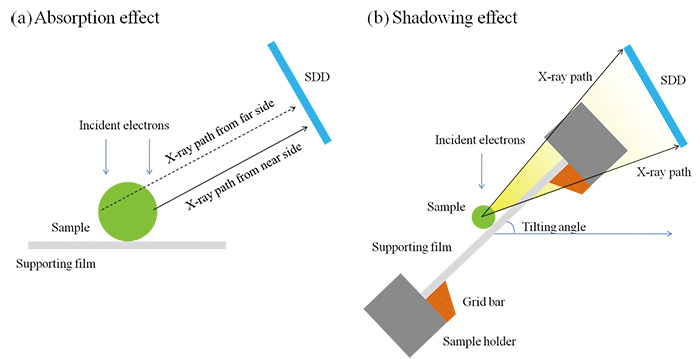
- Эффект поглощения образцом. Рентгеновские лучи с дальней стороны образца поглощаются самим образцом больше, чем с ближней стороны.
- Эффект затенения держателем образца. Рентгеновские лучи от образца блокируются держателем образца или стержнями сетки в определенном диапазоне углов наклона. Черные стрелки показывают путь луча к детекторам EDS.
Fig.2

- Предыдущая система обнаружения ЭДС, состоящая из двух SDD, расположенных симметрично. Один справа от оси наклона, а другой с противоположной стороны.
- Новая конфигурация системы обнаружения ЭДС. Так же есть два SDD, и к оси наклона добавляется SDD2. Ожидается, что количественная томограмма EDS без эффекта затенения может быть получена при использовании только SDD2 для томографии EDS.
Экспериментальный
Микроскоп, использованный для наших экспериментов, представлял собой 300-киловольтный ТЭМ с коррекцией аберраций (JEM-ARM300F, JEOL Ltd.), оснащенный двумя SDD (см. рис. 3). Один детектор расположен на оси наклона держателя образца (SDD2), а другой — справа от оси наклона (SDD1) (рис. 2(б)). Для быстрого получения томограммы ЭДС без эффекта затенения с использованием только SDD2 использовался ТЭМ на 300 кВ, оснащенный новым полюсным наконечником, новым аналитическим держателем с высоким наклоном и крупногабаритными SDD. Новый полюсный наконечник, названный полюсным наконечником с широким зазором (WGP), был спроектирован тоньше, чем предыдущий полюсный наконечник, чтобы детекторы EDS могли приближаться близко к держателю образца. Пространственное разрешение ТЭМ 300 кВ с WGP составляет 0.062 нм благодаря корректору аберраций Cs. Новый аналитический держатель с высоким наклоном был разработан для томографии EDS. Наконечник этого держателя узкий и тонкий, чтобы генерируемый рентгеновский снимок не блокировался для томографии EDS. При использовании этих насадок и крупногабаритных СДД, площадь обнаружения которых составляет 158 мм2, телесный угол только СДД2 достигается более 1.1 ср. Наша система обнаружения EDS может реализовать высокое пространственное разрешение и высокую скорость аналитического счета даже с одним детектором [13].
Мы подготовили два вида образцов для наших экспериментов. Одним из них является образец пленки краски для оценки эффекта затенения в новой системе обнаружения EDS. Другой — полевой транзистор реберного типа (FinFET), который является одним из передовых полупроводниковых устройств. Основная масса пленок краски, залитых эпоксидной смолой, была нарезана методом микротомирования до толщины 200 нм. Тонкие срезы устанавливали на поддерживаемую мембрану из тонкостержневой сетки диаметром 3 мм. Карты 2D EDS были получены с использованием ПЭМ 300 кВ с током зонда 300 пА. Серия карт EDS наклона от -60 до +60 градусов с шагом 5 градусов была автоматически получена программным обеспечением для томографии (TEMography, SYSTEM IN FRONTIER Inc.), которое установлено на управляющем ПК для TEM. Размер каждой карты EDS составлял 256 на 256 пикселей. Размер пикселя составлял 9.766 нм/пиксель. Время сбора данных составило 190 минут. Все карты EDS, взятые в нашем эксперименте, были преобразованы в карты чистых подсчетов из карт подсчетов блеска с теми же условиями с использованием пакетной обработки, реализованной в программном обеспечении анализатора EDS (Analysis StationTM, JEOL Ltd.). В начале процедуры реконструкции наклонные серии изображений HAADF-STEM были выровнены по реперным маркерам, и были реконструированы трехмерные структуры без элементной информации. Алгоритмом трехмерной реконструкции для этой реконструкции был метод одновременной итеративной реконструкции (SIRT). И те же условия выравнивания, и те же условия реконструкции были применены к серии наклонов EDS с использованием пакетной обработки, реализованной в программном обеспечении TEMography. Наконец, мы получили трехмерные карты элементов образцов лакокрасочной пленки.
Образец FinFET был грубо вырезан низкоскоростной алмазной дисковой пилой. Участок образца утоняли механической полировкой. Наконец, образцы были измельчены на ионно-фрезерном станке аргона (Ion SlicerTM, JEOL Ltd.) для наблюдения с помощью ПЭМ [16]. Коллоидные частицы золота диаметром 5 нм наносили на образец и использовали в качестве реперного маркера для выравнивания серии наклонов. ТЭМ работал при ускоряющем напряжении 200 кВ. Серия наклонных карт элементов EDS была автоматически получена в диапазоне углов наклона от +64 до -64 градусов. Шаг по градусу равен 4 градусам. Размер каждой карты EDS составлял 256 на 256 пикселей. Размер пикселя составлял 1.953 нм/пиксель. Плотность тока составляла 300 пА. Общее время сбора данных составило около 120 минут при использовании одного SDD (SDD2). Процедура реконструкции образца FinFET была такой же, как и для образца пленки краски.
Fig.3

- ТЭМ 300 кВ (JEM-ARM300F, JEOL Ltd.) с двумя крупногабаритными SDD, показанными на (b).
- Зона обнаружения 158 мм2.
- Аналитический держатель с большим наклоном, разработанный для томографии EDS. Наконечник держателя уже и тоньше стандартного, чтобы не блокировать генерируемые рентгеновские лучи.
Результаты и обсуждение
Томограммы ЭДС образца пленки краски были получены для оценки эффекта затенения в новой системе обнаружения ЭДС, которая была установлена в ТЭМ 300 кВ. Изображения HAADF и трехмерные карты элементов показаны на рис. 3. Образец пленки краски, состоящий из частиц оксида титана, мелких частиц кремнезема, мелких частиц оксида железа и углеродной смолы, отмечен желтым, зеленым, пурпурным и синим цветами на рис. 4. (б) соответственно. Измеренные значения общей интенсивности Ti Kα по картам ЭДС образца пленки краски нанесены на график в зависимости от угла наклона предметного столика образца в ПЭМ. Красные, синие и зеленые точки, показанные на рис. 4, соответствуют суммарным интенсивностям, обнаруженным SDD5, SDD1 и SDD2+SDD1 соответственно. Поскольку объемы частиц оксида титана на каждой карте EDS постоянны, общая интенсивность на картах Ti Kα должна быть постоянной в результате количественного анализа EDS. Однако интенсивность, обнаруженная SDD2 и SDD1 + SDD1, уменьшилась примерно на -2 градусов из-за эффекта затенения. С другой стороны, интенсивности, обнаруженные SDD20, оставались почти постоянными в диапазоне наклона образца. Этот результат свидетельствует о том, что ЭДС-детектор, расположенный на оси наклона, практически не блокировал рентгеновские лучи от держателя и сетки образца. С помощью этого единственного детектора EDS была реализована почти бестеневая томографическая система EDS.
Для полупроводниковых приборов применялась система бестеневой томографии ЭДС. Изображение HAADF и карты серии наклонов EDS FinFET были получены с помощью ПЭМ 300 кВ, показанного на рис. 6. Белые точки на изображении HAADF соответствуют наночастицам золота, которые использовались в качестве реперных маркеров для выравнивания в 3D. процедура реконструкции. Трехмерные карты элементов FinFET, показанные на рис. 3, были реконструированы с использованием алгоритма SIRT. В полученных картах обнаружены германий, титан, вольфрам, кислород, азот и кремний. Трехмерные структуры электрода затвора на кремниевой подложке четко наблюдались с помощью томографии EDS. Трехмерная карта азота, соответствующая изолирующей пленке, все еще была зашумлена. Более высокая доза электронов или более длительное время сбора данных необходимы для наблюдения трехмерных элементарных распределений легких элементов с высоким отношением сигнал/шум даже при использовании высокочувствительного SDD площадью 6 мм3. На рис. 3 показаны срезы, перпендикулярные направлениям X, Y и Z, извлеченные из полученной трехмерной карты элементарного объема. Положение карты срезов по оси Y обозначено желтой линией на соответствующей карте срезов по оси Z, показанной под картой срезов по оси Y. Германиевый стрессор (желтый), вольфрамовый электрод (зеленый) и кремниевый канал (синий) четко видны на карте Y-образного среза (а). А азот (пурпурный), расположенный между каналом и электродом, был получен на трехмерных картах элементов. Из этих результатов можно сделать вывод, что томография EDS полезна для анализа трехмерных элементарных структур современных полупроводниковых устройств.
В этом исследовании мы попытались устранить эффект затенения в томографии EDS, улучшив конфигурацию детектора в ПЭМ. Однако эффект поглощения также должен быть устранен для трехмерного количественного анализа. Когда образцы состоят из легких элементов вместе с тяжелыми элементами, эффект поглощения был серьезным при количественном трехмерном элементном анализе с помощью томографии EDS. Мы оценили эффект поглощения рентгеновского излучения самим образцом пленки краски с помощью ЭДС-томографии. Набор данных томограммы EDS был получен с помощью ПЭМ на 3 кВ (JEM-F3, JEOL Ltd.), оснащенного двумя SDD, которые были расположены на оси наклона и с правой стороны держателя образца соответственно. Трехмерные карты элементов титана, железа, алюминия, кремния, кислорода и углерода были реконструированы из карт серий наклона EDS образцов пленок краски. Соотношение элементного состава с вокселем к вокселю было рассчитано с использованием метода Клиффа-Лоримера. Мы сравнили соотношения трехмерного состава для трех частиц диоксида титана, которые обозначены желтыми стрелками на рис. 200. Соотношение трехмерного состава для частиц диаметром 200 нм соответствовало тому факту, что частицы представляли собой диоксид титана. Но атомный процент кислорода в частицах диаметром 3 нм и 3 нм был занижен. Считается, что рентгеновские лучи кислорода поглощались самим образцом. Поправки на эффект поглощения необходимы для анализа трехмерного количественного распределения элементов с высокой точностью в томографии EDS.
Fig.4

- HAADF-изображение образца пленки краски, полученное JEM-ARM300F, оснащенным детектором EDS, площадь детектора которого составляет 158 мм2.
- Трехмерное изображение, восстановленное из образца, показанного на (а). Цвета обозначают виды атомов: желтый (Ti), зеленый (Si), пурпурный (Fe) и синий (c).
Fig.5

Карты полной интенсивности Ti Kα образца пленки краски с использованием различных сигналов детектора, нанесенные на график в зависимости от угла наклона. Синие точки, красные точки и зеленые точки соответствуют Ti Kα карты выполнены по сигналам SDD1, SDD2 и SDD1+SDD2 соответственно. Интенсивности, обнаруженные SDD2, были почти постоянными в диапазоне наклона образца для ET.
Fig.6
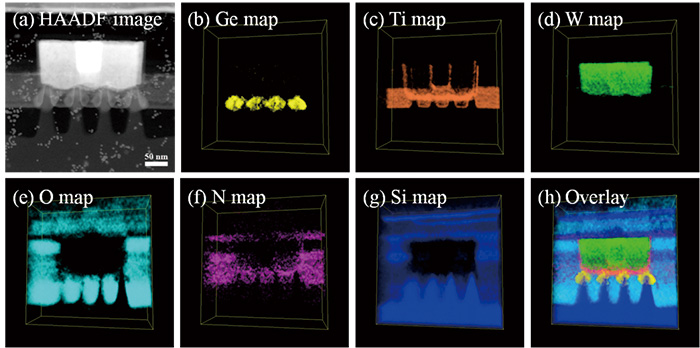
(а) Изображение HAADF образца FinFET, полученное с помощью JEM-ARM300F, оснащенного одним SDD большого размера, площадь обнаружения которого составляет 158 мм.2. Белые точки соответствуют наночастицам золота, используемым в качестве реперных маркеров. (b)-(h) 3D-карты элементов того же образца в (a), реконструированные из карт серии наклонов EDS, показывающие распределение атомов германия, титана, вольфрама, кислорода, азота и кремния соответственно. Образец был утончен ионным измельчением. Размер восстановленного объема составляет (381, 377, 121) нм.
Fig.7

Карты срезов Y-среза и Z-среза, извлеченные из реконструированной трехмерной карты элементарного объема образца FinFET с использованием томографии EDS. (a) и (b) показывают элементарные карты срезов Y-среза в разных положениях, обозначенных желтой линией на соответствующих картах срезов Z-среза ниже. Z-образный срез параллелен поверхности пластины. Германиевый стрессор, вольфрамовый электрод и кремниевый канал и подложка окрашены в желтый, зеленый и синий цвета соответственно.
Fig.8
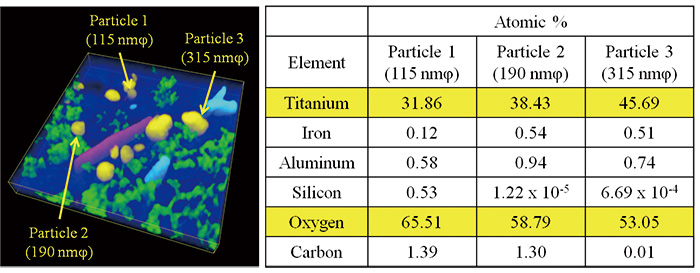
Трехмерная элементная карта образца лакокрасочной пленки, реконструированная с помощью томограммы ЭДС, полученной с помощью JEM-F3, оснащенного SDD с 200 мм2 зона обнаружения (левый рисунок). Трехмерный количественный анализ трех частиц диоксида титана, отмеченных желтыми стрелками, показан в таблице справа. Соотношение состава кислорода в частице 3 и 2 занижено из-за эффекта поглощения рентгеновского излучения. Эффект поглощения нельзя игнорировать для количественного анализа в томографии EDS.
Обзор
Чтобы получить количественный трехмерный элементный анализ, мы разработали новую систему обнаружения EDS для ТЭМ и установили систему на ТЭМ 3 кВ с поправкой на аберрацию. Система детектирования состояла из двух детекторов EDS различной конфигурации, которые располагались на оси наклона предметного столика (SDD300) и справа от оси наклона (SDD2). Зона обнаружения этих SDD составляет 1 мм.2. Кроме того, мы разработали аналитический держатель с большим углом наклона, наконечник которого уже и тоньше, чем у стандартного держателя, чтобы не блокировать генерируемое рентгеновское излучение образцов. При использовании этого микроскопа с этими насадками телесные углы SDD1 и SDD2 составляют 1.106 ср и 1.108 ср соответственно. Томограммы ЭДС образцов пленки краски были получены с использованием новой системы обнаружения ЭДС. Суммарные интенсивности от Ti Kα карты пленки краски были почти постоянными во всем диапазоне наклона образца для томографии. Результат показал, что новая система обнаружения EDS может получать томограммы EDS без эффекта затенения. Трехмерные карты элементов с FinFET были получены без эффекта затенения с использованием новой системы обнаружения EDS. Эффект затенения можно устранить с помощью нашей конфигурации обнаружения EDS. Коррекция эффекта поглощения необходима для анализа трехмерного количественного распределения элементов с высокой точностью в томографии EDS.
Рекомендации
- Д. Хисамото, В. К. Ли, Дж. Кедзиерски, Э. Андерсон, Х. Такеучи, К. Асано, Т. Дж. Кинг, Дж. Бокор и К. Ху, «МОП-транзистор со сложенным каналом для эры глубоких субдесятых микрон», IEDM Tech . Dig., (1998) стр. 1032-1034.
- Х. Танака, М. Кидо, К. Яхаши, М. Оомура, Р. Кацумата, М. Кито, Ю. Фукудзуми, М. Сато, Ю. Нагата, Ю. Мацуока, «Технология масштабирования стоимости долота с процессом штамповки и пробки» для флэш-памяти сверхвысокой плотности », Материалы симпозиума по технологии СБИС, (2007 г.), стр. 14–15.
- А. М. Кормак, «Представление функции ее интегралами с некоторыми радиологическими приложениями», Дж. Прикладная физика, 34 (1963) С. 2722-2727.
- М. Хаяшида, Л. Гунаван, М. Малак, К. Павлович и М. Куйяр, «Высокоточная электронная томография полупроводниковых устройств», микроск. микроанал . 21, 3 (2015) стр. 1609-1610.
- Б. Фу, М. Грибелюк, Л. Дюма, К. Фанг, Н. Ламанк, Л. Ходжкинс и Э. Чен, «Сочетание STEM-томографии и STEM / EDS-анализа дефектов, связанных с образованием NiSi, в литейных цехах полупроводниковых пластин» , микроск. микроанал . 22, 3 (2016).
- К. Лепине, Ф. Лорут, Р. Пантель и Т. Эписье, «Химическая 3D-томография транзистора с металлическим затвором 28 нм с высоким К: экспериментальный метод и результаты STEM XEDS», Микрон 47 (2013) стр. 43–49.
- П. Бурдет, Дж. Ваннод, А. Хесслер-Визер, М. Раппаз и М. Кантони, «Трехмерный химический анализ сваренных лазером никель-титановых проволок из нержавеющей стали с использованием двухлучевого FIB», Акта Матер., 61, 8 (2013), стр. 3090–3098.
- А. Генк, Л. Коварик, М. Гу, Х. Ченг, П. Плачинда, Л. Пуллан, Б. Фрайтаг и К. Ван, «Стволовая томография XEDS для трехмерной химической характеристики наноразмерных частиц», Ультрамикроскопия 131 (2013) стр. 24–32.
- Б. Горис, Л. Полаварапу, С. Балс, Г. Ван Тенделу и Л. Лиз-Марзан, «Мониторинг гальванической замены с помощью трехмерного морфологического и химического картирования», Нано Летт . 146. Т. 2014. С. 3220–3226.
- Г. Мёбус, Р. Доул, Б. Инксон, "Спектроскопическая электронная томография", Ультрамикроскопия, 96, 3–4 (2003), стр. 433–451.
- З. Саги, С. Сюй, Ю. Пэн, Б. Инксон и Г. Мёбус, «Трехмерный химический анализ вольфрамовых зондов с помощью энергодисперсионной рентгеновской нанотомографии», Appl. Phys. Латыш. 91 (2007) с. 25.
- Л. Струедер, П. Лехнер и П. Лойтенеггер, «Кремниевый дрейфовый детектор — ключ к новым экспериментам», Естественные науки 8511. Т. 1998. С. 539–543.
- И. Ониши, К. Миятакэ, Ю. Джимбо, Ю. Ивасава, М. Морита, Т. Сасаки, Х. Савада и Э. Окуниши, «Сверхвысокоэффективная система обнаружения рентгеновского излучения из двух SDD очень большого размера для коррекции аберрации 300». кВ Микроскоп», Труды микроскопии и микроанализа 2016, 22, S3 (2016) стр. 318-319.
- CSM Yeoh, D. Rossouw, Z. Saghi, P. Burdet, RK Leary и PA Midgley, «Темная сторона томографии EDX: моделирование затенения детектора для помощи в трехмерном анализе элементарных сигналов», микроск. микроанал. 213. Т. 2015. С. 759–764.
- Пьер Бурде, З. Саги, А. Н. Филиппин, А. Боррас и П. А. Миджли, «Новый метод трехмерной коррекции поглощения для количественной томографии EDX-STEM», Ультрамикроскопия 160 (2016) стр. 118–129.
- А. Ясухара, "Разработка ионного слайсера (оборудование для подготовки тонкопленочных образцов)", ДЖЕОЛ Новости 40 (2005) С. 46-49.
Связанные товары
Вы медицинский работник или персонал, занимающийся медицинским обслуживанием?
Нет
Напоминаем, что эти страницы не предназначены для предоставления широкой публике информации о продуктах.
