Анализ химического состояния с помощью эмиссионной спектроскопии мягкого рентгеновского излучения
НОВОСТИ JEOL, том 53, № 5
Масами Тераучи и Йохей Сато
Центр передовой микроскопии и спектроскопии, Институт междисциплинарных исследований перспективных материалов, Университет Тохоку
Металлизация Si-sp3 сеть Na8Si46 и распределение химического состояния в CaB, легированном Na6, наблюдали с помощью коммерческого прибора EPMA-SXES. Информация, наблюдаемая в L-излучении 3d элементы из переходных металлов, полученные с помощью оригинального прибора SEM-SXES.
Введение
Для разработки функциональных наноматериалов и наноустройств микроскопический анализ и его обратная связь с производственным процессом являются ключевым вопросом для этих разработок. Для этого решающее значение имеют методы анализа, основанные на электронной микроскопии. В частности, методы спектроскопии дают нам полезную информацию о функциях материала. Рентгеновская спектроскопия для элементного анализа может быть наиболее широко используемой. Существует два типа спектроскопии с дисперсией по энергии (EDS) и спектроскопии с дисперсией по длинам волн (WDS). Электронная спектроскопия потерь энергии (EELS) и катодолюминесценция (CL, связанная с переходом a на рис. 1) также широко используются. В последнее время в группу коммерческих методов входит новое лицо эмиссионной спектроскопии мягкого рентгеновского излучения (МРЭС), которая может дать информацию об электронной структуре [1, 2].
Для исследования электронных структур, связанных с функциями материала, EELS, основанный на просвечивающей электронной микроскопии (ПЭМ), широко используется из-за его лучшего энергетического разрешения, чем у EDS и WDS, и широкого диапазона энергий 1-1000 эВ. EELS может исследовать диэлектрические свойства по спектру возбуждения валентных электронов (возбуждение b на рис. 1). В частности, недавняя коммерциализация инструмента-монохроматора позволила реализовать один нанометровый зонд с энергетическим разрешением 0.1 эВ или лучше. Это позволяет нам анализировать свойства промышленных наночастиц в ближней инфракрасной области [3], а также тепловые колебания решетки [4]. Анализ спектра возбуждения внутренней оболочки (возбуждение c на рис. 1) в сочетании с теоретическим моделированием становится знакомым для оценки связи между электронной структурой и локальной кристаллической структурой. Хотя EELS дает много информации об электронной структуре из области образца в масштабе нанометров, он не может дать информацию о связывающих электронах (валентных зонах). Это может быть реализовано с помощью SXES, который анализирует энергии рентгеновского излучения электронных переходов. d на рис. 1 с энергетическим разрешением лучше 1 эВ. Приборы SXES для электронной микроскопии были разработаны для ПЭМ [5]. Из-за низкой эффективности обнаружения метод был коммерциализирован как инструмент для электронно-зондового микроанализатора (РСМА) и сканирующего электронного микроскопа (СЭМ), которые могут использовать больший зондовый ток, чем у ПЭМ. Поскольку рентгеновское излучение для элементного анализа (EDS, WDS) в основном связано с электронными переходами между уровнями внутренней оболочки (переход e на рис. 1), эти спектры не содержат информации о валентных электронах.
Рис 1

Схематическая диаграмма электронных переходов, связанных с катодолюминесценцией (a), возбуждением валентных электронов EELS (b), спектром возбуждения внутренней оболочки EELS (c), рентгеновским излучением, включая информацию о валентных электронах (d) и обычно используемым рентгеновским излучением. для элементного анализа (д).
Прибор SXES был впервые разработан для ПЭМ [6]. Основным узким местом для применения была низкая эффективность обнаружения. При анализе тонкого образца с высоким пространственным разрешением с помощью ПЭМ объем исследуемого образца невелик, и для получения приемлемого отношения сигнал/шум необходимо время сбора данных в несколько десятков минут или более. При применении этого метода к EPMA и SEM время сбора данных обычно составляет одну или несколько минут из-за большего тока луча и большего объема исследования. Этот метод SXES может быть полезен в качестве метода спектроскопии для объемных материалов, как метод TEM-EELS для тонких образцов. Затем этот EPMA/SEM-SXES может обеспечить быструю обратную связь с обработкой материала.
При объединении спектра EELS возбуждения внутренней оболочки (исследование незанятых состояний) и спектра мягкого рентгеновского излучения (исследование занятых состояний) можно определить все электронные состояния. Кроме того, спектр электронного возбуждения может быть получен из спектра EELS возбуждения валентных электронов с использованием анализа Крамерса-Кронига. Поэтому с помощью электронной микроскопии можно анализировать не только кристаллическую структуру и составные элементы, но и всю электронную структуру выделенных малых участков образца [5, 7].
В этой рукописи наблюдения SXES за металлизацией Si-sp3 сеть Na8Si46, распределение химического состояния в CaB, легированном Na6, и информацию о L-излучении 3d описаны элементы из переходных металлов.
Инструменты и условия эксперимента
Приборы SXES, используемые в этом отчете, показаны на рис. 2 (a) EPMA (JEOL JXA-8230), подключенный к коммерческой системе спектрометра SXES (SS-94000SXES), и (b) SEM (JEOL JSM-6480LV), подключенный к нашему оригинальному спектрометру. . Оба прибора SXES представляют собой спектрометры типа WDS, основанные на плоскопольной оптике скользящего падения с использованием решеток с исправлением аберраций.
Коммерческий прибор SXES с двумя решетками может регистрировать от 50 до 210 эВ за 1st спектр порядка, до 420 эВ для 2nd спектр порядка и многое другое для спектра более высокого порядка. Фактически этот спектрометр может регистрировать сигналы мягкого рентгеновского излучения более 70 элементов [8]. Приведенные данные были измерены с использованием решетки JS200N со средней плотностью штрихов 1200 штрихов/мм. Детектор представляет собой ПЗС тонкостенного типа. Энергетическое разрешение, оцененное для резкой структуры края Ферми, наблюдаемой для L-излучения Al при 72 эВ, составило около 0.2 эВ. Это высокое энергетическое разрешение позволяет нам проводить картирование состояний химической связи.
Оригинальный спектрометр SXES на рис. 2(b) работает в широком диапазоне энергий 50–3800 эВ для спектра 1-го порядка с использованием четырех решеток. В этом отчете использовалась решетка JS2000 со средней плотностью штрихов 2400 штрихов/мм. В качестве детектора использовался многоканальный пластинчатый детектор, оптически связанный с КМОП-камерой. Этот прибор обеспечивает энергетическое разрешение 0.08 эВ в режиме счета фотонов для L-излучения Al [9].
Измерения СРЭС проводились при ускоряющем напряжении 5 кВ. На рис. 2(c) показан спектр L-излучения Al, который вызывает электронные переходы из валентных зон на внутренние уровни L-оболочки, полученный коммерческим спектрометром. Спектр показывает резкую структуру края Ферми при 72 эВ, ожидаемую для алюминия, даже несмотря на то, что поверхность образца окислена. Тонкая структура из-за спин-орбитального расщепления L3 и я2 отчетливо видны уровни 0.4 эВ. Электроны с энергией 5 кэВ, падающие на поверхность алюминия, распространяются внутри материала за счет неупругого рассеяния диаметром около 0.32 мкм, что оценивалось по уравнению Рида d = 0.077 (Eo1.5 - Ec1.5)/ρ (d : размер растекания (мкм), Eo : падающая энергия (кэВ), Ec : критическая энергия возбуждения для желаемого рентгеновского излучения (кэВ), ρ: массовая плотность материала (г/см3)) [10]. Поскольку толщина поверхностного окисленного слоя менее 10 нм, спектр рис. 2(в) обоснованно отнесен к чистому алюминию. Интенсивность излучения поверхностного окисленного слоя проявляется при ускоряющем напряжении менее 1 кВ. На рис. 2(d) показаны спектры L-излучения Fe, полученные нашим оригинальным спектрометром (рис. 2(b)) при ускоряющих напряжениях 2, 5 и 10 кВ. Интенсивность спектра была нормирована по интенсивности излучения Lℓ, которая мало подвержена влиянию поглощения. Видно, что распределение интенсивности излучения Lα,β зависит от ускоряющего напряжения. При более высоком ускоряющем напряжении падающие электроны проникают в более глубокую область от поверхности образца и генерируют рентгеновское излучение, которое претерпевает большее поглощение перед выходом с поверхности. В области энергий L-излучения Fe имеется край поглощения L при 707 эВ (красная пунктирная линия) между излучением Lα и Lβ. Это является причиной значительного уменьшения интенсивности Lβ при большем ускоряющем напряжении. Эффект поглощения меньше при меньшем ускоряющем напряжении, но проявляется влияние поверхностного окисленного слоя. Используя уравнение Рида, распространение электронных пучков в Fe при ускоряющих напряжениях 15 кВ, 5 кВ и 2 кВ оценивается как 0.56 мкм, 0.10 мкм и 0.02 мкм соответственно. Основываясь на приведенных выше экспериментальных результатах и опыте, ускоряющее напряжение 5 кВ было принято в качестве экспериментального условия поверхностной нечувствительности и меньшего эффекта поглощения. Метод спектроскопии при низком ускоряющем напряжении полезен для легко повреждаемых материалов. Недавно пленки аморфного нитрида углерода были успешно проанализированы с помощью SXES при 5 кВ [11].
Рис 2
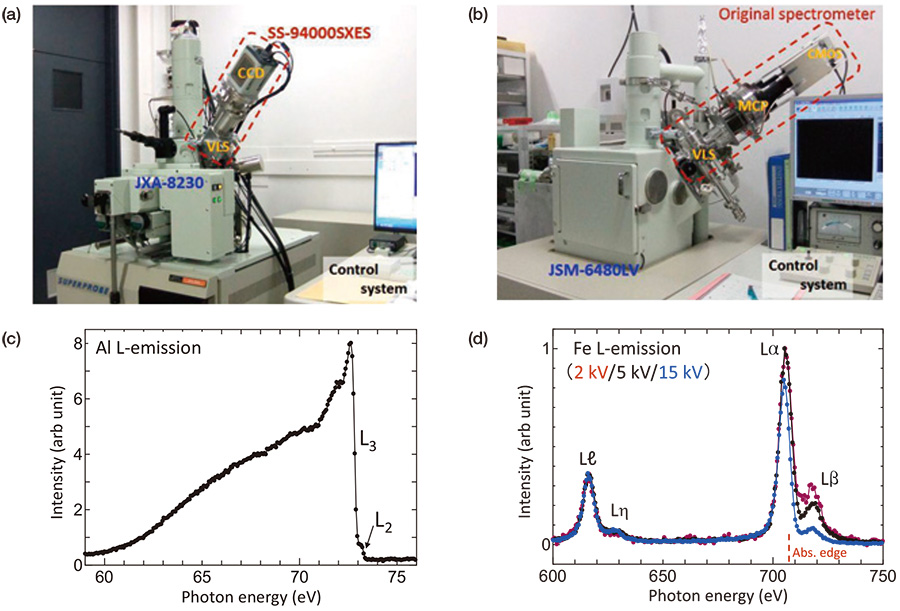
Инструменты SXES, используемые в этом отчете. (a) EPMA (JEOL JXA-8230), подключенный к коммерческой системе спектрометра SXES (SS-94000SXES), и (b) SEM (JEOL JSM-6480LV), подключенный к нашему оригинальному спектрометру. (c) Спектр излучения Al L, полученный с помощью (a). Тонкая структура из-за спин-орбитального расщепления L3 и я2 уровень 0.4 эВ. (d) Спектры L-эмиссии Fe, полученные нашим оригинальным спектрометром (b) при ускоряющих напряжениях 2, 5 и 10 кВ. Интенсивность спектра нормализовали по эмиссии Lℓ.
Металлизация Si sp3 сеть в На8Si46
На рисунке 3 (а) показана кристаллическая структура клатрата Na-Si типа I Na.8Si46. Этот материал на основе трехмерного Si-sp3 сеть ковалентных связей, которая соответствует замене водородных связей в газовых гидратах ковалентной связью Si-Si. Этот Си-sp3 связующая сеть включает Si20 (додекаэдр) и Si24 (тетракаидекэдра) клетки. Атомы Na располагаются в этих клетках. Си-sp3 связующая сеть имеет полупроводниковый характер. Однако атомы Na в клетках передают свой валентный электрон сетке Si, что придает Na металлический характер.8Si46 [12]. На рис. 3(б) показано СЭМ-изображение используемого объемного кристалла. Спектр Si L-излучения, полученный из обведенной кружком области (b) с использованием прибора на рис. 2(a), показан на (c). Спектр Si L-излучения кремниевой пластины (полупроводник) также показан для сравнения. Эти распределения интенсивности обусловлены переходами от валентных зон к внутренним Si-L.2,3 уровней с p симметрия. Благодаря правилу дипольного отбора эти распределения интенсивности отражают плотность состояний валентной зоны с s и d симметрии. Этикетки L2 " и я1 написанные в спектре кремниевой пластины, указывают на особые точки на зонной диаграмме кубического кристалла кремния. Эта двухпиковая структура кажется общей для двух материалов. Он может происходить из Si-sp3 связующая сеть для обоих материалов. Вопреки этому сходству правый конец, где соответствует вершине валентной зоны, отличается друг от друга. На8Si46 показывает острый пик. Из сравнения с теоретическим расчетом этот острый пик можно отнести к состоянию связи между клеткой Si и атомами Na [13]. Для более четкого выяснения различия спектр Na8Si46 увеличено на рис. 3(d). На правом конце спектра виден резкий спад интенсивности шириной 0.2-0.3 эВ, обозначенный вертикальной линией. Поскольку ширина сравнима с энергетическим разрешением измерения, это резкое изменение интенсивности можно отнести к структуре края Ферми, что, по-видимому, указывает на то, что этот материал является металлом.
Рис 3

( а ) Кристаллическая структура клатрата Na-Si типа I Na8Si46. (b) СЭМ-изображение используемого объемного кристалла. (c) Спектр излучения Si L, полученный из области, обведенной кружком на (b). (г) Увеличенный спектр Na8Si46 соответствует вершине валентной зоны. Резкий спад интенсивности шириной 0.2-0.3 эВ, отмеченный вертикальной линией, соответствует краевой структуре Ферми.
Картирование химического состояния CaB, легированного Na6
Кристаллическая структура CaB6 состоит из сети B6 восьмиугольные кластеры, которые расположены в каждом углу кубической элементарной ячейки, и атом металла в положении центра тела ячейки (рис. 4 (а)). Атом Ca может передать два валентных электрона атому B6 кластерная сеть. Поскольку Б6 кластерная сеть может принять два электрона в валентной зоне, CaB6 становится полупроводником (n-тип). Для реализации термоэлектрического устройства с использованием B6 кластерные сетевые материалы [14], pнужен полупроводник. Поскольку атом Na имеет только один валентный электрон, замещение Na на позицию Ca представляет собой дырочное легирование B.6 кластерная сеть, вызывающая pполупроводник [15]. Согласно оценке EDS, содержание Na в материале составляло несколько процентов. Однако однородность материала не оценивалась. Затем кусок CaB, легированный Na,6 материал был исследован с использованием коммерческого инструмента SXES-EPMA на рис. 2 (а).
На рис. 4(b) и (c) показано изображение во вторичных электронах (SE) и изображение в обратно рассеянных электронах (BSE) области CaB, легированного Na.6, соответственно. Изображение SE показывает немного другую морфологию поверхности в верхней левой области, где был обнаружен углеродный сигнал. Изображение BSE показывает область более низкой интенсивности в центре. Затем было проведено картирование SXES. Карты спектральной интенсивности Ca-l, интенсивности η (150–154 эВ), интенсивности BK (170–188 эВ) и верхней части интенсивности BK (187–188 эВ) показаны на рис. 4(d), (д) и (е) соответственно. Карта выбросов Ca-ℓ, η показывает низкую интенсивность темной области изображения BSE. Это означает низкое содержание Ca в этом районе. Карта эмиссии BK не показывает явного изменения интенсивности в этом районе. С другой стороны, карта верхней части интенсивности излучения BK на рис. 4(f) показывает большую интенсивность для области. Для исследования происхождения этого увеличения интенсивности на рис. 5 представлены эмиссионные спектры BK точек A и B, показанные на рисунке. кластерная сеть. Следует отметить, что пик спектра А, указанный стрелкой, расположен в сторону более высоких энергий примерно на 6 эВ по сравнению с пиком спектра В. Этот сдвиг спектра А должен быть химическим сдвигом, возникающим из-за энергетического сдвига уровня B 0.7s в сторону большей энергии связи. Этот сдвиг основного уровня может быть связан с уменьшением валентного заряда атомов B. Ожидается, что для Na-допированного CaB6. К сожалению, существующая система не может определять интенсивность эмиссии Na-K (скоро появится в виде коммерческой версии). Примесный кислород также может быть источником, потому что атомы O принимают электроны. На самом деле крошечная интенсивность при 175 эВ в спектре А может быть отнесена к 3rd порядка интенсивности излучения ОК. В любом случае, мягкое рентгеновское картирование с высоким энергетическим разрешением может дать нам картирование химического сдвига, отражающее величину валентного заряда.
Рис 4
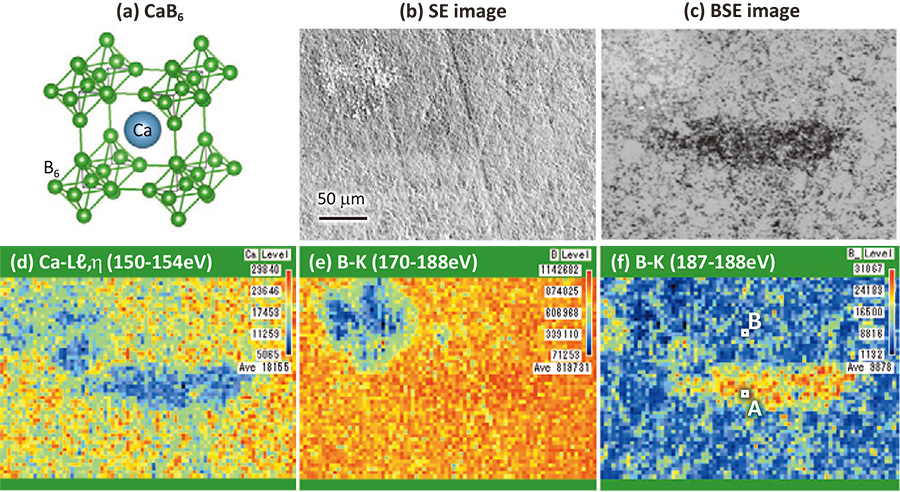
(а) Кристаллическая структура CaB6. (b) Изображение во вторичных электронах (SE) и (c) изображение в обратно рассеянных электронах (BSE) CaB, легированного Na6. Карты спектральной интенсивности (d) Ca-l, интенсивности η (150–154 эВ), (e) интенсивности BK (170–188 эВ) и (f) верхней части интенсивности BK (187–188 эВ).
Рис 5
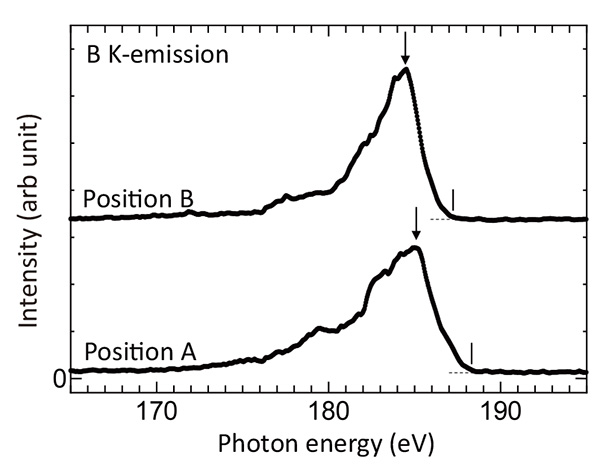
Спектры эмиссии БК точек А и Б показаны на рис. 4(е).
Информация о L-излучении 3d элементы из переходного металла
Состояние связи и валентность 3d переходный металл (3d-TM) является ключом для оценки материалов положительного электрода литий-ионной батареи, поскольку изменение валентности 3dЭлементы ТМ являются источником заряда и разряда батареи. Информация о валентных электронах 4s и 3d из 3d -элементы ТМ включены в L-выбросы элементов. Поскольку эти энергии 1st спектры порядка выходят за пределы энергетического диапазона коммерческого спектрометра SXES, оригинальный спектрометр (рис. 2(б)) применялся для оценки спектров L-эмиссии Ti и его оксидов [16], а также Fe и его оксидов. Существует четыре типа L-излучения Lα, Lβ , Lℓ и яη , Lα и яβ излучения обусловлены переходами валентных электронов на внутренние L3-оболочка и L2-скорлупа соответственно. Таким образом, эти интенсивности включают информацию об энергетических состояниях 3d электроны. С другой стороны, Лℓ и яη выбросы обусловлены переходами с мелкого уровня внутренней оболочки M1 к более глубокому L3 и я2 уровней соответственно. Таким образом, информация, включенная в Lℓ,η , отличается от Lα,β. На рис. 6 показана схема этих переходов. Переходы от М2,3 к L2,3 запрещены правилом дипольного отбора.
На рис. 7 показано (а) L α,β эмиссия и (б) Lℓ,η эмиссионные спектры металла-Ti, недавно опубликованного монооксида ε-TiO и TiO2 (рутил). Хорошо видно, что распределения интенсивности излучения L α,β различны для разных материалов. Они отражают, что энергетические состояния связывающих электронов различны для разных атомных схем или кристаллических структур. В простой ионной модели TiO2 рассматривается как Ti4+O-22 и не может излучать интенсивность L α,β, поскольку Ti4+ ион не имеет 3d электрон. Поскольку в эксперименте наблюдаются эмиссии L α,β, атом Ti в TiO2 не чистый Ti4+ ион через ковалентную связь между Ti и окружающими атомами O. При обсуждении распределения интенсивности излучения L α,β необходимо учитывать не только плотность состояний валентных зон, но и энергетический сдвиг уровня внутренней оболочки (химический сдвиг). Кроме того, необходимо учитывать перекрытие распределений интенсивности Lα и Lβ и наличие края поглощения между Lα и Lβ. С другой стороны, распределение интенсивности Lℓ,η из-за переходов между двумя уровнями внутренней оболочки гораздо легче обсуждать.
Lα пиковая энергия TiO2 примерно на 2 эВ меньше, чем у металлического титана. В свою очередь, L л пиковой энергии TiO2 на 0.7 эВ больше, чем у металла-Ti. Позиция ε-TiO почти такой же, как у металлического Ti. В случае Fe и его оксидов, показанных на рис. 7(c), л металла-Fe и Fe3O4 почти такая же энергетическая позиция. л Fe2O3 Позитоны немного выше по энергии, примерно на 0.2 эВ, чем другие. Это говорит о том, что происхождение энергетических сдвигов Lα и Lβ не простое. Большее отношение интенсивностей Lβ /Lα в оксидах Fe может быть связано с подавлением процесса Костера-Кронига в оксидах [18].
На основе обсуждения сдвига энергии связи из-за изменения химических эффектов в рентгеновской фотоэлектронной спектроскопии информация, включенная в Lα а интенсивность эмиссии Lℓ заключают следующим образом [16]. Изменение Lα распределение интенсивности излучения отражает изменения валентного заряда и твердотельные эффекты (кристаллическое поле, плотность состояний, ширина запрещенной зоны и т.д.). Изменение положения пика Lℓ вызвано изменением M1 эффект керна в конечном состоянии, отражающий локальный эффект экранирования. Код WIEN2k был использован для оценки разницы эффекта керна-дырки в металле и его оксидах. Значения TiO2 по сравнению с металлом-Ti и Fe2O3 по сравнению с металлом-Fe были +0.7 эВ и +0.2 эВ соответственно. Эти значения хорошо воспроизводят экспериментально наблюдаемые значения. Эти сдвиги пиков из-за эффекта сердечника-дырки тесно связаны с диэлектрическими свойствами, шириной запрещенной зоны исследуемого материала [19, 20].
Рис 6

Схематическая диаграмма электронных переходов, связанных с эмиссией Lα,β и Lℓ,η.
Рис 7
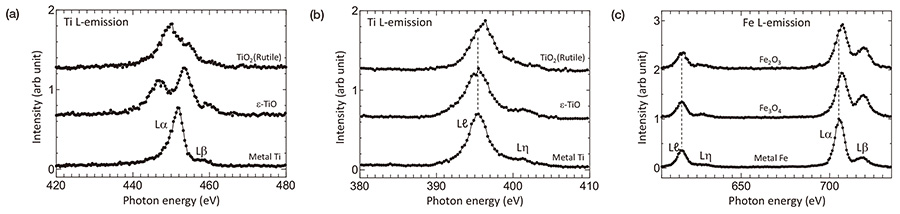
(а) спектры эмиссии Lα,β и (б) спектры эмиссии Lℓ,η металлического титана, недавно опубликованного ε-TiO и TiO2 (рутил). (c) Fe L-эмиссионные спектры металлического Fe и его оксидов.
Заключение
Недавно выпущенный в продажу инструмент SXES для EPMA и SEM имеет энергетическое разрешение 0.2 эВ для излучения Al-L, что примерно в 10-100 раз лучше, чем у WDS и EDS. Этот метод SXES полезен в качестве метода спектроскопии для анализа химического состояния и картирования сыпучих материалов в качестве метода TEM-EELS для тонких образцов. Поскольку нет необходимости в подготовке тонких образцов, этот EPMA/SEM-SXES может обеспечить быструю обратную связь с процессами производства материалов. Этот прибор обеспечивает метод спектроскопии электронов связи не только для широкого спектра новых функциональных материалов, но и для фундаментальных исследований соединений.
Благодарности
Авторы благодарят доктора Х. Морито из Института исследования материалов Университета Тохоку за предоставление монокристалла клатрата Na-Si. Исследование SXES на CaB, легированном Na6 является совместным исследованием с профессором М. Такеда из Технологического университета Нагаока. Оценка химических сдвигов L-излучения 3d элементы из переходных металлов с использованием кода WIEN2k были совместной работой с доктором С. Кошия и доктором К. Кимото из Национального института материаловедения. Эти работы были частично поддержаны Исследовательской программой «Динамического альянса открытых инноваций, соединяющих человека, окружающую среду и материалы» в «Сетевом объединенном исследовательском центре материалов и устройств».
Ссылки
- Х. Такахаши, Т. Мурано, М. Такакура, Н. Ханда, М. Тераучи, М. Койке, Т. Кавати, Т. Имазоно, Н. Хасэгава, М. Коэда, Т. Нагано, Х. Сасаи, Ю. Оуэ, З. Йонезава и С. Курамото, ДЖЕОЛ Новости , 49, 73 (2014).
- Х. Такахаши, Т. Мурано, М. Такакура, С. Асахина, М. Тераучи, М. Койке, Т. Имазоно, М. Коэда и Т. Нагано, ИОП конф. Серия: Материаловедение и инженерия , 109, 012017 (2016).
- Ю. Сато, М. Тераучи и К. Адачи, Журнал прикладной физики , 112, 074308 (2012).
- О. Л. Криванек, Т. С. Лавджой, Н. Деллби, Т. Аоки, Р. В. Карпентер, П. Рез, Э. Суаньяр, Дж. Чжу, П. Э. Бэтсон, М. Дж. Лагос, Р. Ф. Эгертон и П. А. Крозье, природа, 514, 209 (2014).
- М. Тераучи, глава 7 в Просвечивающая электронная микроскопия Характеристика наноматериалов , изд. Кумар CSSR (Springer-Verlag), 287 (2014).
- М. Тераучи, Х. Ямамото и М. Танака, Журнал электронной микроскопии , 50, 101 (2001).
- М. Тераучи и М. Кавана, Ультрамикроскопия , 106, 1069 (2006).
- М. Тераучи, Х. Такахаши, М. Такакура и Т. Мурано, Справочник по спектрам излучения мягкого рентгеновского излучения вер. 3 (IMRAM Tohoku Univ. & JEOL), (2016).
- М. Тераучи, Х. Такахаси, М. Такакура, Т. Мурано, М. Койке, Т. Имазоно, Т. Нагано, Х. Сасаи и М. Коэда, Микроскопия и микроанализ , 22 (Приложение 3), 414 (2016).
- SJB Рид, Электронный микрозондовый анализ, 2-е издание (Издательство Кембриджского университета), 200 (1993).
- С. Исии, М. Тераучи, Ю. Сато, Н. Тамура, М. Аоно и Х. Абэ, представлен на микроскопию (2018).
- А. Мовес, Э.З. Курумаев, Дж.С. Це, М. Геши, М.Дж. Фергюсон, В.А. Трофимова и Ю.М. Ярмошенко, Phys. Ред. Б, 65, 153106 (2002).
- З. Вэй, К. Цин-Юн, З. Чжао-И и К. Лин-Цан, Подбородок. физ. Б , 24, 107101 (2015).
- М. Такеда, М. Теруи, Н. Такахаси и Н. Уэда, J. Химия твердого тела , 179, 2823 (2006).
- Х. Курибаяси, С. Макино и М. Такеда, Аннотация ISBB-18 , 148 (2014).
- М. Тераучи, С. Кошия и К. Кимото, ИОП конф. Серия: Материаловедение и инженерия, 304, 012018 (2017).
- С. Амано, Д. Богдановски, Х. Ямане, М. Тераучи и Р. Дронсковски, Angewandte Chemie , 55, 1652 (2016).
- Э. Антонидес и Г.А. Савацкий, Дж. Физ. C: Физика твердого тела., 9, Л547 (1976).
- К. Хиросе, М. Кихара, Х. Окамото, С. Синагава, Х. Нохира, Э. Икенага, М. Хигучи, А. Терамото, С. Сугава, Т. Оми и Т. Хаттори, Письма по прикладной физике, 89, 154103 (2006).
- К. Хиросе, Х. Судзуки, Х. Нохира, Э. Икенага, Д. Кобаяси и Т. Хаттори, J. Физика: серия конференций, 100, 01211 (2008).
Связанные товары
Вы медицинский работник или персонал, занимающийся медицинским обслуживанием?
Нет
Напоминаем, что эти страницы не предназначены для предоставления широкой публике информации о продуктах.
