Анализ органических тонких пленок [Приложение MALDI]
Профилирование глубины с использованием изображений масс-спектрометрии Ag SALDI и XPS
Введение
Масс-спектрометрия вторичных ионов (SIMS) — это аналитический метод, который используется для изучения органических соединений на поверхности образцов. Когда SIMS используется для визуализации масс-спектрометрии (MSI), он может создавать изображения с высоким пространственным разрешением для ионизированных аналитов. Однако ВИМС часто дает сложные масс-спектры в результате фрагментации исходных соединений. Эта фрагментация вызвана избыточной внутренней энергией первичного ионного пучка, используемого для ионизации. Недавно методы MSI, в которых используются методы мягкой ионизации, такие как матричная лазерная десорбция/ионизация (MALDI) и поверхностная лазерная десорбция/ионизация (SALDI), использовались для получения достоверной информации о молекулярной массе, которая более четко показывает распределение органических соединений на поверхности образца. . Эти методы особенно полезны для анализа поверхностей образцов со смесями органических соединений. Для MALDI-MSI матричный раствор распыляется на поверхность образца для повышения эффективности ионизации органических соединений. Однако нанесение раствора матрицы на поверхность может вызвать несколько проблем: (i) раствор может вызвать миграцию целевых соединений, что изменит их распределение на поверхности, и (ii) интенсивность ионов может колебаться в результате изменений в матрице. кристаллообразование (десятки микрон). В результате снижается практическое пространственное разрешение и затрудняется определение глубины зондирования. В качестве альтернативы, для Ag SALDI-MSI наночастицы серебра осаждаются без растворителя на поверхность образца толщиной 10 нм (рис. 1), что улучшает пространственное разрешение и упрощает определение глубины зондирования.
В этом отчете мы сделали двухслойную органическую тонкую пленку разной толщины для контроля глубины зондирования Ag SALDI-MSI. Мы также выполнили профилирование по глубине того же образца с использованием рентгеновской фотоэлектронной спектроскопии (XPS) в сочетании с газовым кластерным ионным пучком (GCIB).
Масс-спектрометр: JMS-S3000 "SpiralTOF™"
JMS-S3000 "SpiralTOF™" (рис. 2а) представляет собой времяпролетный масс-спектрометр MALDI (TOFMS), который имеет спиральную траекторию ионов, состоящую из четырех электростатических секторов (рис. 2b). Общая длина траектории полета ионов для SpiralTOF™ составляет 17 м (в пять раз больше, чем у традиционной TOFMS), что позволяет достичь самого высокого разрешения по массе, коммерчески доступного для системы MALDI TOFMS. Кроме того, помехи от химического фона уменьшаются за счет устранения ионов распада после источника в электростатических секторах. Эти особенности являются преимуществом для обнаружения второстепенных компонентов на загрязненных поверхностях проб.
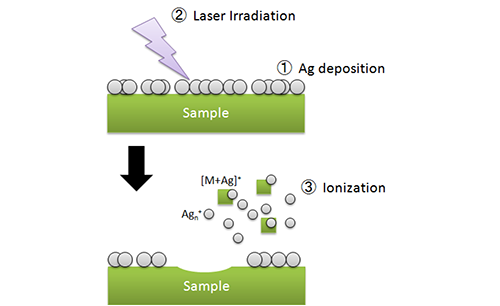
Рис.1 Принцип Ag SALDI.

Рис.2 а) JMS-S3000 "SpiralTOF™" и б) спиральная траектория иона.
Рентгеновская фотоэлектронная спектроскопия: JPS-9030
JPS-9030 — это XPS-система, которую можно использовать для анализа элементного состава и состояния химической связи на поверхности образца (рис. 3). Рентгеновские лучи облучают поверхность образца для генерации фотоэлектронов от различных поверхностных аналитов (рис. 4). Глубинное профилирование элементного состава и состояния химической связи возможно при сочетании XPS и GCIB. Недавно эти методы были применены к органическим образцам, которые легко повреждаются при использовании кластерных ионов газа для ионного травления.
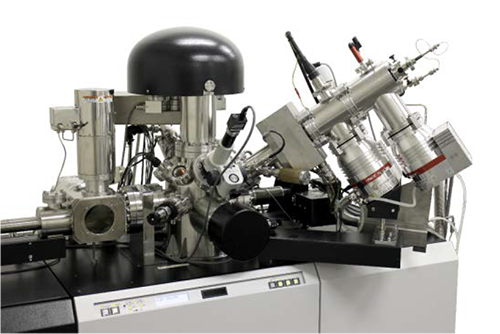
Рис.3 Рентгеновский фотоэлектронный спектрометр JPS-9030.

Рис.4 Принцип рентгеновской фотоэлектронной спектроскопии.
Подготовка образца: двухслойная пленка
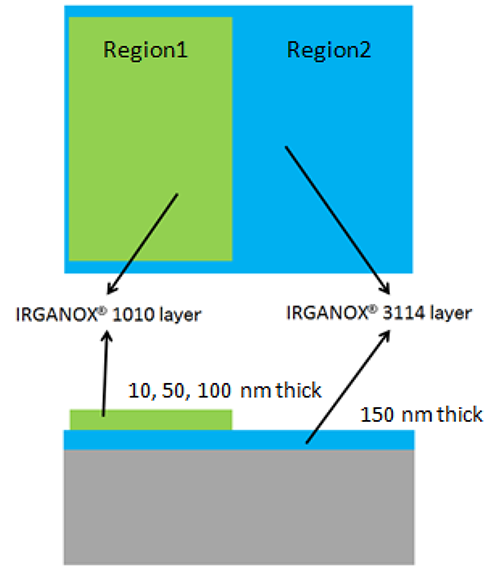
Рисунок 5. Схема двухслойной тонкой пленки
Двухслойные тонкие пленки были изготовлены с использованием IRGANOX 1010 (C73H108O12) и IRGANOX 3114 (C48H69N3O6). Сначала на кремниевую пластину наносили слой IRGANOX 150 толщиной 3114 нм. Затем на половину пленки IRGANOX 1010 наносили IRGANOX 3114 толщиной 10, 50 или 100 нм. Эта двухслойная пленка IRGANOX 1010/3114 обозначается как область 1, тогда как область только IRGANOX 3114 обозначается как область 2 (рис. 5). Серебро было нанесено на области 1 и 2 толщиной 10 нм. После этого для изучения наночастиц серебра на поверхности образца использовали FE SEM JSM-7610F (рис. 6а). Ускоряющее напряжение 5 кВ использовалось для наблюдения изображений вторичных электронов (рис. 6b). Серые области в форме островков на изображении SEM — это настоящие наночастицы серебра. Это изображение показывает, что наночастицы были равномерно распределены по поверхности образца. Следует отметить, что поле зрения для изображения SEM намного меньше, чем диаметр лазера (20 мкм), используемый во время Ag SALDI-MSI.
IRGANOX является зарегистрированным товарным знаком или товарным знаком BASF SE.

Рисунок 6. а) JSM-7610F и б) SEM-изображение Ag-NP, нанесенного на поверхность образца.
Условия измерения
Профилирование IRGANOX 1010/3114 по глубине было выполнено с использованием SALDI-MSI и XPS с GCIB. Условия измерения перечислены ниже. Во время измерений XPS спектры были получены для каждых 10 нм от поверхности IRGANOX до кремниевой пластины путем травления пучком кластерных ионов Ar.
Таблица 1. Условия измерения SALDI-MSI и XPS
| САЛДИ-МСИ | XPS |
|---|---|
|
JMS-S3000 Спиральный TOF™ |
ДЖПС-9030 |
Результаты и обсуждение
1. АГ САЛДИ-МСИ
Результаты Ag SALDI-MSI для слоев IRGANOX 10 толщиной 50, 100 и 1010 нм показаны на рис. 7 ac. Это массовые изображения для [M+Ag]+ IRGANOX 1010 и IRGANOX 3114. Каждая граница тонкой пленки для области 1 и 2 показана на массовых изображениях IRGANOX 1010 зеленым (наблюдается) и черным (не наблюдается). Профили линий для Ag SALDI-MSI были измерены вдоль красной пунктирной линии на рисунке 7a, а результаты показаны на рисунке 7d. Относительная интенсивность ионов для профилей линий была нормализована по средней интенсивности IRGANOX 3114 в области 2. Интенсивность нижнего слоя IRGANOX 3114 уменьшалась по мере увеличения толщины верхнего слоя IRGANOX 1010. Наконец, ионы не были обнаружены под слоем IRGANOX 100 толщиной 1010 нм. Таким образом, глубина зондирования для измерений Ag SALDI-MSI составляла 50–100 нм, что больше, чем может анализировать XPS без GCIB. В следующем разделе XPS был объединен с GCIB для измерения профиля глубины области IRGANOX 1010 (50 нм)/3114.

Рис. 7. Масс-изображения ионов аддукта серебра ([M+Ag]+) для IRGANOX 1010/3114, полученного с использованием Ag-NP SALDI-MSI (ac). Также показан профиль линии аддукта ионов серебра IRGANOX 3114 (d).
2.Профилирование глубины с использованием XPS и GCIB
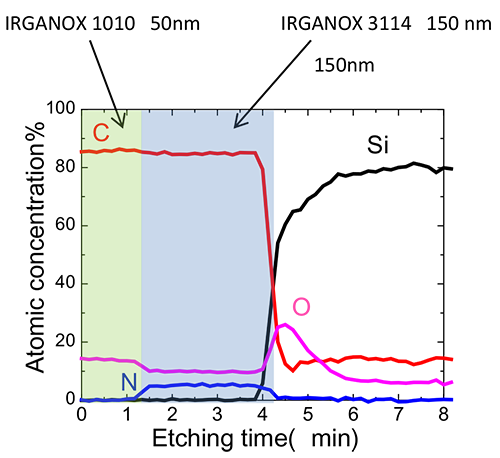
Рисунок 8. Профилирование глубины для 1010(50 нм)/3114
(150 нм) с использованием XPS с GCIB.
XPS комбинировали с GCIB для определения профиля глубины IRGANOX 1010 (50 нм)/3114 (150 нм). Изменение атомных концентраций углерода, азота, кислорода и кремния показано на рисунке 8. Атомная концентрация кремния использовалась для контроля полного удаления органического слоя с помощью травления кластерными ионами аргона, которое заняло приблизительно четыре минуты (см. Рисунок 8). Атомная концентрация азота использовалась, чтобы отличить IRGANOX 3114 (содержащий азот) от IRGANOX 1010 (без азота). Комбинация XPS и GCIB использовалась для профилирования по глубине с шагом 10 нм при отслеживании различий в соотношениях элементного состава для целевых слоев.
Это разрешение по глубине 10 нм дает преимущество по сравнению с Ag SALDI-MSI, который может получать только среднюю информацию на глубине 50 нм для органических слоев, как описано ранее. С другой стороны, если соотношения элементного состава для каждого слоя демонстрируют минимальные различия, то важно проанализировать поверхность с помощью Ag SALDI-MSI, чтобы идентифицировать фактические молекулы, присутствующие на/в поверхности.
Заключение
- Ag SALDI-MSI и XPS/GCIB использовались для изучения двухслойной тонкой пленки IRGANOX 1010 на IRGANOX 3114.
- На тонкую пленку был нанесен слой наночастиц серебра толщиной 10 нм для измерений Ag SALDI-MSI.
- Было определено, что глубина зондирования Ag SALDI-MSI составляет от 50 до 100 нм.
- Глубина зондирования для XPS в сочетании с GCIB была определена равной 10 нм.
Подтверждение
Мы хотели бы поблагодарить профессора Мацуо и доктора Фуджи из Киотского университета за предоставление двухслойных тонких пленок.
- Если вы хотите увидеть печатную версию,
пожалуйста, щелкните этот файл PDF. 
PDF 897.8KB
Вы медицинский работник или персонал, занимающийся медицинским обслуживанием?
Нет
Напоминаем, что эти страницы не предназначены для предоставления широкой публике информации о продуктах.
