Определение характеристик атомного разрешения с использованием JEOL JEM-ARM200CF с коррекцией аберраций в Университете Иллинойса в Чикаго
JEOLnews, том 49, номер 1, 2014 г.
Роберт Ф. Кли, Ахмет Гулек, Ариджита Мукерджи, Тадас Паулаускас,
Ци ао Ци ао, Сюэ Жуй, Рунже Тао, Цаньхой Ван, Тад Дани эль,
Патрик Дж. Филлипс, Алан В. Николлс
Университет штата Иллинойс в Чикаго
Современные сканирующие трансмиссионные электронные микроскопы (STEM) с коррекцией аберраций предоставляют множество методов характеризации, которые можно применять в широком диапазоне длин и температурных шкал. В Иллинойском университете в Чикаго исправленная аберрация эмиссионная система JEOL JEM-ARM200CF с холодным полем позволяет получать изображения с атомарным разрешением, анализ потерь энергии электронов (EEL), а также энергодисперсионную рентгеновскую спектроскопию (XEDS) в диапазон температур от 80 до 1,300 К. Возможности этого прибора будут продемонстрированы с помощью ряда исследований, посвященных как структурным, так и химическим свойствам материалов, включая NbH, SrTiO3, CdTe и белок ферритин. Центральной темой этих исследований является универсальность микроскопа, которая реализуется за счет способности выполнять химические характеристики атомного масштаба при сохранении высокого пространственного разрешения изображения. Особый интерес для многих исследований представляет визуализация легких элементов, таких как N, O или H, с использованием одновременной визуализации кольцевого темного поля под большим углом (HAADF) и кольцевого светлого поля (ABF). Будут продемонстрированы новые возможности на месте с использованием графеновых жидких ячеек. Наконец, мы продемонстрируем влияние нового кремниевого дрейфового детектора Oxford X-MaxN 100TLE на выполнение XEDS-картирования с разрешением по атомным столбцам при различных масштабах длины и энергетическом разрешении.
Введение
Лучшее понимание механизмов, которые влияют на свойства материала на атомном уровне, необходимо для разработки новых функциональных наноустройств для электроники, энергетики и биологических приложений, важно, чтобы мы получили понимание. Даже в большей степени, чем на макроскопическом уровне, когда компонент был миниатюризирован для использования в наноустройствах, поверхности, интерфейсы и отдельные дефекты доминируют в его свойствах, изменяя структурные, композиционные и связующие свойства материала. Для успешного изготовления рабочих и надежных устройств крайне важно, чтобы мы понимали взаимосвязь структуры и свойств этих дефектов, интерфейсов и поверхностей.
За последнее десятилетие аналитическая просвечивающая электронная микроскопия (TEM) и сканирующая TEM (STEM) стали основными инструментами для изучения взаимосвязей между структурой и свойствами новых наноматериалов [1-15], в частности атомной и электронной структур дефекты, интерфейсы или наночастицы [16-20] . Сканирующий просвечивающий электронный микроскоп (STEM), оснащенный корректором аберраций на стороне зонда, такой как JEOL JEM-2200FS или JEOL JEM-ARM200F [21-24], обеспечивает беспрецедентное пространственное разрешение как тяжелых, так и легких химических соединений. С пространственным разрешением фазово-контрастной визуализации высокого разрешения (HRTEM) с коррекцией аберраций и высокоугольным кольцевым темным полем, HAADF (или Z-контрастом) в STEM с коррекцией аберраций, теперь достигающим фундаментального предела радиуса Бора,0~ 50 часов, фокус смещается на увеличение химического разрешения и визуализацию всех составляющих атомных частиц при сохранении пространственного разрешения. С этой целью спектроскопия потерь энергии электронов (EELS) и энергодисперсионная рентгеновская спектроскопия (XEDS) доведены до точки, когда с помощью обоих методов становится возможным составление химических карт с атомарным разрешением [25, 26]. Внедрение кремниевых дрейфовых детекторов (SDD) с большей активной площадью детектора в XEDS значительно способствовало этому продвижению, что привело к демонстрации чувствительности к одному атому [27]. Многие системы материалов используются в устройствах в условиях (т.е. температурах, давлениях или полях), которые существенно отличаются от тех, которые существуют внутри колонки электронного микроскопа. В обычном просвечивающем электронном микроскопе с атомарным разрешением исследования с атомным разрешением ранее ограничивались температурой окружающей среды и высоким вакуумом (PO2= 10-5 Па) из-за невозможности установить держатели in-situ в небольшой зазор полюсного наконечника объектива сверхвысокого разрешения. За последнее десятилетие эта область значительно продвинулась вперед, и теперь доступны возможности для изучения динамического поведения материалов на месте в средах, отличных от высокого вакуума колонки TEM. Новые конструкции столиков для образцов позволили нагреть на месте до 1,300 К с атомарным разрешением, провести эксперименты с газом и жидкостью на месте с нанометровым разрешением, а также получить изображения с временным разрешением с разрешением выше наносекунды. В этой статье будут продемонстрированы возможности JEOL JEM-ARM200CF в Университете Иллинойса в Чикаго, STEM зонда с коррекцией аберраций, оснащенного источником электронов с эмиссией холодного поля, послеколоночного EEL-спектрометра и нового Oxford X-MaxN 100TLE. Детектор SDD-XEDS. Мы продемонстрируем, что визуализация легких элементов, включая N, O и H, с атомарным разрешением возможна с использованием изображений ABF, в то время как источник электронов с эмиссией холодного поля позволяет использовать EELS с энергетическим разрешением лучше, чем 400 мэВ. Кроме того, мы расскажем о нашем недавно разработанном подходе к графеновым жидким ячейкам для инкапсуляции биологических образцов, таких как белки ферритина, в жидкость между двумя отдельными слоями графена.
Экспериментальный
JEOL JEM-ARM200CF установлен в Центре исследовательских ресурсов (RRC) Университета Иллинойса в Чикаго (Рис 1) оснащен пушкой с холодной полевой эмиссией, 5 кольцевыми детекторами, спектрометром Gatan Enfina EELS и новым детектором Oxford X-Ma xN 10 0TLE SDD EDS и был установлен в нашей лаборатории в конце 2011 г. Пространственное разрешение, которое теперь может обычно достигается с использованием JEOL JEM-ARM200CF, превышает 70 пм при первичной энергии 200 кВ (см. Рис 2(а)) и 100 м при первичной энергии 80 кВ. Энергетическое разрешение спектров EEL при любой энергии от 80 до 200 кВ составляет 350 мэВ (см. рис. 2(b)). Стабильность прибора была измерена с использованием изображения HAADF с длинной выдержкой без коррекции drift и была определена как лучше 150 пм/мин. В дополнение к держателям с двойным наклоном мы также получили столик для охлаждения жидкого гелия с двойным наклоном Gatan, столик для нагрева с двойным наклоном Protochips Aduro, столик для томографии Fischione, а также столик Nanofactory STM-TEM и проточную ячейку для жидкости Protochips Poseidon. . Кроме того, у нас все еще есть доступ к двухконтурному отоплению Gatan и двухконтурному отоплению LN.2 ступени охлаждения, которые были закуплены в 1998 году для использования в UIC JEM-2010F.
В этой статье мы покажем результаты нескольких из этих стадий на месте, включая Gatan LN.2 этап охлаждения и самодельная графеновая жидкая ячейка. Эти результаты призваны продемонстрировать широкий спектр экспериментов, которые можно проводить ежедневно на ARM200CF. На этом этапе важно отметить, что переключение между режимами TEM и STEM может быть выполнено без значительного нарушения выравнивания или стабильности инструмента. Например, при переключении из режима TEM в режим STEM можно достичь атомарного разрешения практически сразу после ручной коррекции комы и астигматизма. При самом высоком разрешении изображения мы замечаем, что в течение первых 60-120 минут после входа в режим STEM необходима некоторая настройка фокуса и стигматора. Когда ARM200CF находится в режиме STEM в течение двух часов, прибор становится полностью стабильным.
UIC JEOL JEM-ARM200CF расположен в пользовательском помещении с открытым доступом, что позволяет квалифицированным пользователям использовать прибор 24 часа, 7 дней в неделю на основе почасовой оплаты [28]. Поэтому крайне важно, чтобы любые экспериментальные настройки, необходимые пользователю, не влияли на производительность инструментов для последующих пользователей. На сегодняшний день мы не испытали какого-либо значительного влияния каких-либо экспериментов на месте или низковольтных измерений на вакуумную колонну или характеристики энергетической стабильности в течение более чем нескольких часов после завершения экспериментов.

Рис. 1 JEOL JEM-ARM200CF в Университете Иллинойса в Чикаго.

Рис. 2 а) Изображение HAADF при 200 кВ Si (110) с преобразованием Фурье, показанным на вставке. b) Пик без потерь с указанной полной шириной на половине максимума.
Результаты и обсуждение
Здесь мы обсудим результаты нескольких экспериментов, проведенных с использованием JEOL ARM200CF в Университете Иллинойса в Чикаго. Материалы, которые были охарактеризованы, включают SrTiO3 тонкие пленки на GaAs, ß-NbH, поликристаллическом CdTe и белках ферритина в графеновой жидкой ячейке.
Характеристика SrTiO при низком напряжении3/GaAs-интерфейсы
За последние несколько лет сверхтонкие пленки оксидов металлов на полярных поверхностях полупроводников привлекли большое внимание из-за появления новых межфазных свойств, включая сегнетоэлектричество, сверхпроводимость и наличие межфазного 2-мерного электронного газа [29-34]. XNUMX]. Первый успешный рост SrTiO3 о тонких пленках на Si было сообщено более двух десятилетий назад, и использовались различные методы для послойной сборки кристаллической оксидной пленки и предотвращения образования аморфного слоя на границе раздела [35, 36].
СрТиО3 /GaAs были изучены экспериментально и теоретически с использованием различных методов, чтобы развить фундаментальное понимание взаимосвязей структурных свойств, и было сообщено, что SrTiO3 пленка предпочтительно должна быть SrO на границе раздела, независимо от условий роста, и субмонослой Ti, далее именуемый предварительным слоем Ti, между оксидом и полупроводником может высвободить закрепление уровня Ферми после осаждения тонкой пленки. 37-39]. Однако из-за дефицита кислорода в пленке было невозможно выполнить спектроскопию потерь энергии электронов (EELS) с атомарным разрешением на высокочувствительном к пучку SrTiO.3/GaAs интерфейс [40].
Используя JEOL ARM200CF в UIC, мы провели детальное исследование атомной и электронной структуры SrTiO.3/GaAs с предварительным слоем Ti и без него с использованием изображений HAADF и EELS при энергии первичных электронов 80 кВ [41]. Рисунок 3 показаны Z-контрастные изображения с атомным разрешением 4-х монослойного тонкого SrTiO3 пленка на GaAs (001), где очевидна эпитаксия с SrTiO3(001) || GaAs (001) и SrTiO3[110] || GaAs [100] . Интерфейс между SrTiO3 Пленка и носитель GaAs (рис. 3) выглядят четкими, без явной межфазной диффузии. Кроме того, изображения показывают, что оксидные пленки начинаются со слоя SrO на границе раздела GaAs, оканчивающейся As, независимо от того факта, что 0.5 ML предварительного слоя Ti было нанесено на поверхность GaAs до SrTiO.3 роста для образца, показанного на рис. 3(а)). В отличие от экспериментов, проведенных при энергии первичных электронов 200 кВ, SrTiO3Интерфейсы /GaAs в настоящее время достаточно стабильны, чтобы выдерживать визуализацию с атомарным разрешением и спектроскопию в течение продолжительных периодов времени. Даже несколько часов анализа конкретной области образца до сих пор не показали никаких признаков повреждения луча ни в Z-контрастной визуализации, ни в спектроскопии.
Полученные Ti L- и O K-ребра показаны на Рис 4 и Рис 5, соответственно полученные с использованием полуугла сходимости 30 мрад, полуугла сбора 35 мрад, с дисперсией 0.1 эВ/пиксель и временем выдержки 3 с. Верхний спектр на рис. 4 и рис. 5 взят из SrTiO3 объемный образец, таким образом, обеспечивающий тонкую структуру Ti4+ в качестве эталона. На рис. 4 расщепление кристал- лического поля краев Ti L3 и L2 может быть четко разрешено во всех спектрах, полученных от SrTiO.3 тонкая пленка, что указывает на то, что валентность Ti близка к 4+ во всех пленках как с предварительным слоем Ti, так и без него [42]. Для дальнейшей оценки валентного состояния Ti и, следовательно, стехиометрии кислорода в пленках шкала энергии была откалибрована с использованием начала O K-края, как показано на рис. 4.
Теперь можно видеть, что в пленке без предварительного слоя Ti L-края Ti для каждого места в пленке слегка сдвинуты в сторону более низкой энергии, что снова указывает на небольшое уменьшение Ti. Точнее, оба L3 и я2 края смещаются в сторону более низких энергий по мере приближения электронного зонда к SrTiO3/GaAs, что указывает на уменьшение валентности Ti с 4+ до состояния смеси 3+ и 4+ [42]. Такие явления могут быть вызваны кислородными вакансиями или тем, что состояние связи Ti-O на TiO2 столбцы в тонкой пленке изменились на Ti-As на поверхности подложки. Кроме того, здесь интересно отметить, что сигнал Ti заметен по крайней мере в двух слоях подложки GaAs, что указывает на то, что часть Ti диффундировала в подложку GaAs во время синтеза пленки. На рис. 2 полученные O K-ребра подогнаны к своим 5th ближайших соседей и по сравнению с эталонным спектром, взятым из объемного SrTiO3. Цветные спектры соответствуют цветным прямоугольникам на рис. 3. Сразу видно, что тонкая структура O K-края в SrTiO3 тонкие пленки существенно отличаются от объемного SrTiO3, особенно для пленки, выращенной без предварительного слоя Ti. В частности, в спектрах пленок [43, 44] сильно масштабирующийся предпик при наличии вакансий кислорода подавляется в спектрах пленок [XNUMX, XNUMX], что свидетельствует о наличии кислородных вакансий. Кроме того, вблизи SrTiO3/GaAs тонкая структура O K-края имеет несколько пиков, которые не были обнаружены в объемном SrTiO3, ни в фильмах SrTiO3 спектры. Эти дополнительные пики указывают на связывание кислорода с мышьяком на поверхности GaAs на начальных этапах синтеза тонкой пленки. Наконец, интегральная интенсивность O K-края полностью исчезает в подложке GaAs даже в тех местах, где был обнаружен сигнал Ti. Это также указывает на то, что в носитель диффундирует только Ti, а кислород остается в SrTiO.3 пленки и на поверхности GaAs.
Таким образом, наше исследование визуализации и спектроскопии при низком напряжении показывает, что, хотя атомная структура интерфейсов не обнаруживает никаких признаков предварительного слоя Ti на SrTiO3 на границе раздела электронная структура пленок существенно отличается. Пленки, выращенные без предварительного слоя Ti, кажутся более дефицитными по кислороду и демонстрируют сильное взаимодействие между подложкой из GaAs и межфазным кислородом, потенциально образуя As.2O3. Осаждение предварительного слоя Ti, по-видимому, уменьшает окисление подложки и, следовательно, поднимает пиннинг уровня Ферми [41].
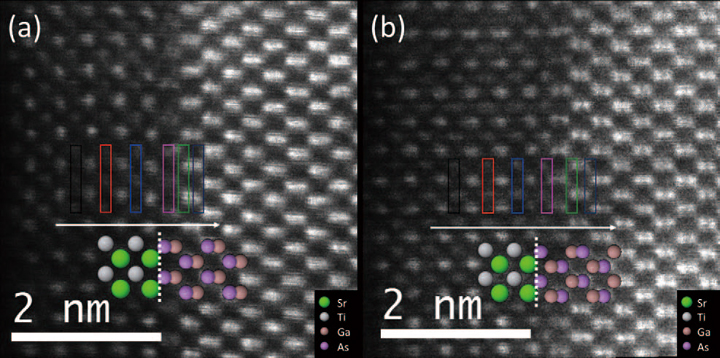
Рис. 3 Изображение HAADF с атомарным разрешением при 80 кВ SrTiO3 /GaAs а) с и б) без предварительного слоя Ti.
Цветным прямоугольником выделена область, где были получены спектры EEL. На изображения наложена модель атома, а граница раздела обозначена пунктирной линией.

Рис. 4 EELS при 80 кВ L-краев Ti после вычитания фона для образца а) с предварительным слоем Ti и б) без него.

Рис. 5 EELS при 80 кВ L-краев Ti после вычитания фона для образца а) с предварительным слоем Ti и б) без него.
Спектры EELS O K-краев для образцов а) с и б) без предварительного слоя Ti. Заштрихованная область показывает спектры, полученные из SrTiO.3 пленка, а верхний спектр взят от объемного SrTiO3 в качестве ссылки.
Прямая визуализация водорода в ß-NbH
ниобий, а 4d переходный ион металла нашел множество применений, включая хранение водорода, гетерогенный катализ, диэлектрические покрытия и сверхпроводящие устройства, такие как сверхпроводящие радиочастотные (SRF) резонаторы [45]. В ускорителях следующего поколения производительность резонаторов SRF при умеренных (т.е. 16-19 МВм-1) и высокие электрические (т.е. >35 МВм-1) градиенты поля являются критическими [46]. Тем не менее, даже после десятилетий исследований, до сих пор отсутствует четкое понимание микроструктурных дефектов, ограничивающих характеристики среднего и сильного поля. Однако представляется ясным, что гидрид ниобия, если он присутствует, может вносить основной вклад в ухудшение показателя качества Q, поскольку осадки гидрида могут быть сверхпроводящими только за счет эффекта близости и их преждевременного перехода в состояние сверхпроводимости. нормальное состояние приведет к сильным потерям [47, 48].
Здесь мы представляем исследование с атомным разрешением образования выделений β-NbH при комнатной температуре в зернах Nb вблизи поверхностей полости. [49] Кроме того, мы демонстрируем, что изображения с атомарным разрешением все еще возможны в LN.2 температуры, хотя пространственный дрейф ограничивает время задержки на пиксель примерно до 16 мкс/пиксель.
Рисунок 6 показывает пару изображений HAADF и ABF, полученных одновременно, преципитата ß-NbH в ориентации [110]. В то время как изображение HAADF очень похоже на изображение чистого Nb, изображение ABF показывает дополнительные столбцы атомов, которые можно идентифицировать как столбцы атомов водорода. На вставке к рис. 6 показана предполагаемая структура ß-NbH [110], а также расчет контраста изображения с использованием многосрезового метода. Контраст в расчетах изображения согласуется с этим показателем в экспериментальных изображениях ABF. Используя комбинацию изображений ABF, селективной дифракции электронов и EELS, мы подтвердили, что фазовое изображение представляет собой ß-NbH [110].
Согласно фазовой диаграмме для Nb-гидрида существует несколько других фаз в зависимости от локальной концентрации водорода и температуры. Таким образом, чтобы полностью понять роль гидридных выделений в характеристиках градиента среднего и сильного поля резонаторов SRF на основе ниобия, метод визуализации, обеспечивающий атомарное разрешение при низкой температуре (например, LN2 температура) нужна. Использование двойного наклона Gatan LN2 этапе мы визуализировали объемный Nb [110] (Рис 7(б)) и показать, что при этой температуре возможно достижение атомарного разрешения. Однако из-за увеличения механических вибраций в результате выкипания азота нам пришлось уменьшить время задержки пикселя до 16 мкс/пиксель и усреднить по нескольким изображениям для достижения презентабельного отношения сигнал/шум. При необходимости можно использовать более сложные процедуры шумоподавления, если повторное получение изображений с короткой выдержкой невозможно.
![Рис. 6. Одновременные изображения HAADF и ABF при 200 кВ ß-NbH [110], на которых отчетливо видны столбцы атомов водорода на изображении ABF.](https://www.jeol.com/solutions/applications/details/product_file/file/e49_02-fig6.jpg)
Рис. 6. Одновременные изображения HAADF и ABF при 200 кВ ß-NbH [110], на которых отчетливо видны столбцы атомов водорода на изображении ABF.
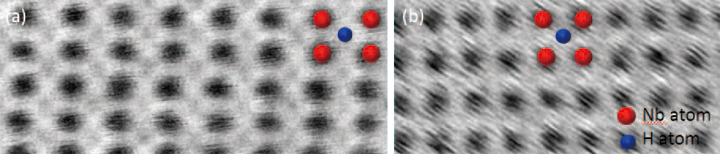
Рис. 7. Изображения ABF с атомарным разрешением 200 кВ при а) комнатной температуре и б) температуре LN2. На обоих изображениях показаны столбцы атомов Nb, но столбцы водорода не очень хорошо видны на низкотемпературном изображении из-за повышенной вибрации образца.
XEDS-анализ дефектов в поликристаллическом CdTe
Поликристаллические фотоэлектрические устройства на основе тонких пленок CdTe являются лидерами в тонкопленочных солнечных технологиях ([50], [51]). Коммерческий успех устройств на основе CdTe обусловлен почти идеальной шириной запрещенной зоны материала, который очень эффективно сочетается со спектром нашего солнечного света, а также простотой изготовления и низкой стоимостью модулей. Однако для повышения эффективности преобразования выше 20% крайне важно свести к минимуму вредное влияние границ зерен и дефектов решетки в CdTe. Желательны прямые структурные и химические исследования на атомном уровне, чтобы идентифицировать атомные конфигурации, которые могут действовать как центры рекомбинации носителей заряда. Точно так же необходимо подтвердить, что пассиваторы, введенные в CdTe, способны диффундировать и связываться с целевыми дефектами. Помимо произвольно ориентированных границ зерен, дефекты упаковки и границы двойников Ʃ3, лежащие на плоскостях {111}, являются очень распространенными планарными дефектами в CdTe. Эти дефекты имеют правильное связывание ближайших соседей, однако беспорядок упаковки становится очевидным во вторых (и последующих) ближайших соседях. Хотя эти интерфейсы считаются безопасными с точки зрения центров рекомбинации носителей, их роль в привлечении примесей и точечных дефектов против узлов остается неизвестной. В Рис 8, мы показываем изображение HAADF и изображение XEDS дефекта упаковки в CdTe вдоль [110]. В этой проекции столбцы атомов Cd и Te образуют гантелеобразную структуру с расстоянием между столбцами 162 пм. Данные XEDS ясно показывают атомарное разрешение, и можно легко определить полярность плоского дефекта. Точнее, направление гантелей при дефекте упаковки поворачивается примерно на 250° [110]. На рисунке 8 показано, что завершающим столбцом левой стороны интерфейса является Te, за которым следует Cd. Такие данные позволят нам количественно оценить возможные изменения стехиометрии на двойниковых границах и дефектах упаковки, обнаружить присутствие примесей и определить атомную структуру ядер дислокаций, замыкающих такие дефекты.
Изображение HAADF и карта XEDS с атомным столбцом дислокации Ломера-Коттрелла вдоль оси зоны [-1-10] в CdTe представлены на Рис 9. В частности, на изображении HAADF видны два внутренних дефекта упаковки, а изображение спектра XEDS показывает интегрированную интенсивность L-пиков Cd и Te в дефектах упаковки. Ядро дислокации расположено в вершине двух пересекающихся дефектов упаковки и состоит из трех столбцов атомов Cd и одного столбца Te (Cd3Te), как это видно из карты изображения спектра, представленной на рис. 8. Здесь следует отметить, что без наличия изображения спектра XEDS идентификация столбцов атомов в ядре дислокации была бы невозможна, так как атомные номера (Z) для Cd и Te слишком близки, чтобы их можно было различить с помощью одного только изображения HAADF.

Рис. 8 STEM-изображение HAADF, полученное через границу двойника, просмотр с наложением серий Cd L (красный) и Te L (синий). Масштабная линейка составляет 1 нм и применяется к картам отдельных элементов.
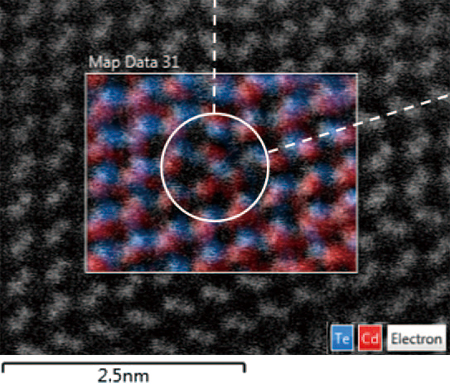
Рис. 9 a) Карта XEDS с атомарным разрешением, наложенная поверх Z-контрастного изображения в проекции <110>. Ядро дислокации LC (обведено кружком) связано с двумя внутренними дефектами упаковки, заштрихованными.
Ферритин в графеновой жидкой ячейке
Рост наночастиц, химические реакции или биохимическая активность часто происходят в присутствии жидкости. Для изучения жидкого образца в электронном микроскопе в последние годы стали коммерчески доступными несколько конструкций жидкостных ячеек, которые позволяют визуализировать материалы в тщательно контролируемой жидкой среде в вакууме ПЭМ. Однако все они имеют несколько ключевых ограничений, которые не позволяют получать изображения или спектроскопию со сверхвысоким разрешением: [52] 1) два Si3N4 слои (толщиной 50-500 нм), используемые в качестве электронно-прозрачных окон и 2) толщина жидкости, окружающей образец. В этих жидких ячейках разрешение изображения обычно ограничено нанометрами. Электронная спектроскопия потерь энергии (EELS) ухудшается из-за событий многократного рассеяния в толстых слоях окна и сильных сигналов основных потерь, связанных с присутствием Si и N [53]. В дополнение к увеличенной толщине образца радиационное повреждение является фундаментально ограничивающим фактором при исследовании чувствительных к лучу материалов и/или содержащих воду образцов в ПЭМ. Было показано, что покрытие образца углеродом, металлом или графеном [54-58] или понижение температуры [57] оказывают положительное влияние на радиационное повреждение за счет уменьшения электростатического заряда, потери массы, потери кристалличности или скорости образования дефектов. [54-58] . Эти исследования показывают, что радиационное повреждение можно уменьшить до уровня ниже разрыва ковалентных связей. Однако для характеристики биологических образцов необходимо дальнейшее снижение радиационного повреждения, поскольку многие биологические структуры и функции связаны с гораздо более слабыми водородными связями.
Мы разработали биосовместимый подход к инкапсуляции жидкостей, содержащих образцы, в монослои графена. Это не только позволяет напрямую визуализировать биологические образцы с атомарным разрешением в нативном жидком состоянии без ограничений по толщине окна (см. Рис 10), но также позволяет проводить анализ в масштабе нм с использованием EELS для количественной оценки реакций в водной среде [59]. Здесь следует отметить, что любая визуализация или химический анализ графеновых жидких ячеек требуют, чтобы энергия электронного пучка была снижена ниже 100 кВ, а изображения, показанные на рис. 10, получены при 80 кВ.
Кроме того, мы показали, что энергия, выделяемая налетающими электронами, рассеивается графеном из облучаемой области со скоростью, эквивалентной току пучка, составляющему несколько электронов на Å2 в секунду [59]. Таким образом, это обеспечит снижение радиационного повреждения, позволяя получать изображения с высоким разрешением и спектроскопию материалов, чувствительных к лучу. Детали, такие как отдельные атомы Fe (см. рис. 10) или полипептид неокрашенного белка, разрешаются в жидкой среде. Тщательно контролируя мощность дозы индуцированных электронов, мы показали, что реакционные ионы, такие как фазовый переход жидкость/газ (образование пузырьков и конденсация) или рост наночастиц/нанопроволок, могут быть инициированы в выбранных местах в ГЖХ и зарегистрированы с разрешением в нм. Этот метод также позволяет нам проводить количественное исследование влияния радиационного повреждения на различные инкапсулированные образцы, такие как вода или белок, путем наблюдения за локальными реакционными процессами.
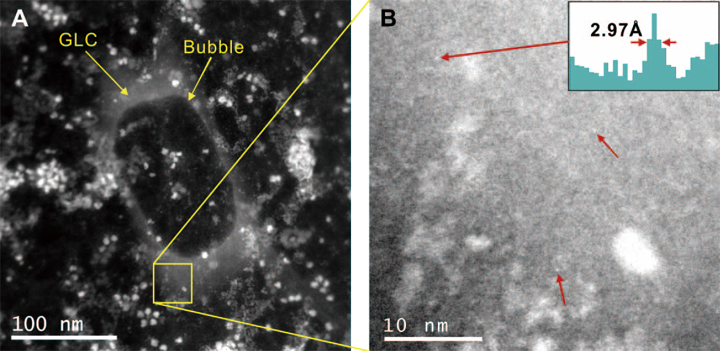
Рис. 10 HAADF (A и B) изображения ферритина в графеновой жидкой ячейке (GLC). Пузырьки в (А) были сформированы заранее с использованием режима ронхиграммы для подтверждения присутствия жидкости. В режиме STEM мощность дозы электронов и время пребывания пикселя оптимизируются таким образом, что во время сканирования больше не образуются пузырьки. Отдельные атомы железа разрешены в жидкой среде на изображении (B) у края ГЖХ. Профиль линии через верхний левый атом показан как вставка (B), где каждый пиксель соответствует 0.99 Å. Разрешение этих изображений оптимизируется путем получения изображений под соответствующей пороговой площадью усредненной мощности дозы образования пузырьков при каждом увеличении.
Заключение
Спустя почти два года после поставки нового JEOL ARM200CF в UIC мы продемонстрировали возможности прибора работать с разрешением менее Å и субэВ в различных условиях с использованием электронного пучка с первичной энергией 200 кВ. Пространственное разрешение уменьшается на 1.0 Å для низкоэнергетического изображения при 80 кВ без потери аналитических возможностей прибора. Кроме того, ARM200CF способен визуализировать образцы в жидкой среде при повышенных или криогенных температурах в режиме ПЭМ или STEM.
Благодарности
Автор выражает признательность за поддержку этой работы со стороны Национального научного фонда [DMR-0846748] и Министерства энергетики США (DOEEE0005956). Приобретение UIC JEOL JEMARM200CF поддерживается MRI-R2 грант Национального научного фонда [DMR-0959470]. Поддержка со стороны Центра исследовательских ресурсов МСЖД также приветствуется.
Рекомендации
[1] Хасимото, А., и др., Прямые доказательства наличия атомных дефектов в графеновых слоях. Природа, 430(7002): с. 870-873 (2004).
[ 2 ] Regan, BC, et al., Углеродные нанотрубки как наноразмерные массовые конвейеры. Природа, 428(6986): с. 924-927 (2004).
[ 3 ] Cumings, J., PG Collins, и A. Zettl, Materials - Peeling and Sharing Multiwall nanotubes. Природа, 406(6796): с. 586-586 (2000).
[4] Иидзима, С., Спиральные микротрубочки графитового углерода. Природа, 354(6348): с. 56-58 (1991).
[5] Ван, З. Л. и З. Канг, К., Функциональные и интеллектуальные материалы.: Plenum Press (1998).
[6] Отомо, А., и др., Искусственная модуляция заряда в сверхрешетках титаната перовскита атомного масштаба. Природа, 419(6905): с. 378-380 (2002).
[7] Zuo, JM, et al., Визуализация углеродных нанотрубок с атомным разрешением по интенсивности дифракции. Наука, 300(5624): с. 1419-1421 (2003).
[8] Белл А.Т. Влияние нанонауки на гетерогенный катализ. Наука, 299(5613): с.
Вы медицинский работник или персонал, занимающийся медицинским обслуживанием?
Нет
Напоминаем, что эти страницы не предназначены для предоставления широкой публике информации о продуктах.
