Растровые электронные микроскопы (РЭМ, SEM)
Растровый электронный микроскоп
Чемпион наблюдения микро- и нано-особенностей поверхности

Первым шагом научного исследования является наблюдение. Сначала невооруженным глазом. Потом мы пытаемся рассмотреть более тонкую структуру, используя лупу, потом микроскоп. Однако возможности оптического микроскопа ограничены свойствами света. Рассмотреть детали, которые меньше длины волны света, достаточно сложно.
Представленный здесь растровый электронный микроскоп (РЭМ) использует пучок, длина волны которых значительно меньше, чем у света, и поэтому становится возможным наблюдение структур размером до нескольких долей нм.
1 нм = одна миллиардная доля метра = 10-9m
Растровый электронный микроскоп → РЭМ или SEM, иногда пишут СЭМ
Растровые электронные микроскопы используются в различных отраслях науки и производства, таких как медицина и биология, геология и археология, криминалистика, материаловедение, производство материалов (металлов, полупроводников, керамики и др.), и дальше расширяет область своего применения. Благодаря применению большого количества разнообразного дополнительного навесного оборудования его возможности постоянно расширяются. РЭМ считается одним из самых мощных инструментов, используемых в научно-исследовательских институтах и лабораториях по контролю качества по всему миру.
Наблюдение за микромиром с помощью электронов
Растровый электронный микроскоп (далее «РЭМ») разрешает более мелкие поверхностные структуры, чем в оптическом микроскопе (далее «ОМ»). Более того, значительно большая глубина фокуса позволяет строить трехмерные изображения, как если бы мы смотрели обычный объект бинокулярным зрением.
РЭМ использует электроны для формирования увеличенного изображения образца так же, как и в просвечивающем электронном микроскопе (далее «ПЭМ»). Меньшая, чем у видимого света, длина волны электрона позволяет нам наблюдать меньшие вещи, чем можно увидеть с помощью ОМ. Слово «разрешение» относится к наименьшему размеру, который можно четко наблюдать (кратчайшее расстояние между двумя соседними точками… считается, что разрешение человеческого глаза составляет 0.2 мм). Разрешение ПЭМ составляет от 0.1 до 0.3 нм, а разрешение РЭМ — от 0.5 до 4 нм. Разрешение РЭМ ниже, чем у ПЭМ, потому что большее ускоряющее напряжение последнего позволяет получить электроны больших энергий и, соответственно, меньших длин волн. Кроиме того, худшее разрешение РЭМ связано, также, с особенностью работы системы электромагнитных линз, используемых для фокусировки электронных лучей.
ПЭМ обеспечивает проецирование увеличенного изображения на флуоресцентный экран электронами, прошедшими через тонкий образец. Для сравнения, РЭМ формирует изображение, регистрируя электроны, которые были отражены или сгенерированы поверхностью образца.
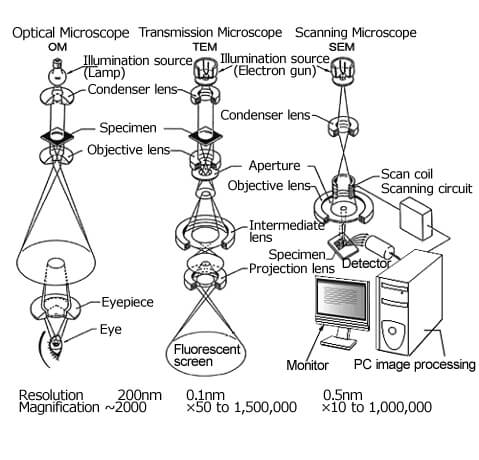
Почему образец можно наблюдать с помощью электронов?

Под действием первичных электронов образец излучает различные сигналы, интенсивность которых зависит от свойств образца (рельефа поверхности, плотности и элементного состава). В-основном это вторичные электроны, обратнорассеянные электроны, характеристическое рентгеновское излучение и катодолюминесценция.
Растровый электронный микроскоп (РЭМ) обычно формирует изображения, регистрируя вторичные электроны. Поскольку интенсивность испускаемых вторичных электронов зависит от угла падения электронов на поверхность образца, тонкие изменения шероховатости поверхности влияют на яркость сигнала.
Пример (образец: печатная плата)

Легко получаемые четкие (псевдо) объемные изображения

Теперь давайте рассмотрим процесс формирования изображения на примере биологического образца.
Биологический образец нуждается в предварительной обработке, называемой пробоподготовкой. Во-первых она необходима, чтобы свести к минимуму повреждения образца потоком высокоэнергетических электронов. Кроме того, она нужна для того, чтобы предотвратить деформацию образца в результате его обезвоживания в вакууме.
Образец проходит сушку после химической фиксации, чтобы предотвратить деформацию при удалении воды, далее фиксируется на постаменте с помощью специальной пасты или липкой ленты. Затем вся поверхность образца покрывается тонким слоем металла, таким как Au или Pt-Pd, с использованием различных методов напыления. Металлическое покрытие предотвращает образование заряда на поверхности образца и увеличивает выход вторичных электронов, что способствует получению более контрастного изображения. После того, как подготовка образца завершена, постамент фиксируется на предметном столике микроскопа, а затем камера образцов откачивается. Откачка проходит автоматически и быстро.

Теперь вы готовы работать с прибором, чтобы сделать наблюдение. Это настолько просто, что не требуется никакой специальной квалификации, такой как водительские права. Установите ускоряющее напряжение, например, 20 кВ (примерно такая же энергия электронов, как у цветного телевизора). Более высокие ускоряющие напряжения дают лучшее разрешение, но также увеличиваются повреждения образца. Если вы хотите наблюдать за поверхностью образца с очень небольшими повреждениями, следует использовать низкое ускоряющее напряжение, например несколько кВ. Затем нагрейте нить накала, чтобы испустить электроны. Они фокусируются в электронный луч, регулируя линзу магнитного поля с помощью ручки управления. Некоторые инструменты оснащены функцией автоматической фокусировки. Далее настройте увеличение. Вы определяете интересующую вас область, выполняя поиск при малом увеличении, а затем можете постепенно увеличивать увеличение, чтобы отобразить и записать увеличенное изображение.

Как видно на правом фото, большая глубина фокуса, чем у оптических микроскопов, позволяет РЭМ создавать четкие трехмерные изображения.
Эта фотография была сделана на РЭМ в режиме низкого вакуума и искусственно раскрашена для зрелищности.
Фотография:
Предоставлено профессором Такаси Цурухара и г-ном Хидэхиро Касахара - Токийский университет Гакугей, биология
(золотое покрытие после сушки вымораживанием в пробирке с образцом после фиксации/дегидратации)
Отличная производительность для наблюдения за поверхностью и анализа
Существует много типов сканирующих электронных микроскопов, от обычного типа, в котором в качестве источника электронов используется вольфрамовая нить накала, до более специализированного типа, в котором с установленной электронной пушкой с автоэлектронной эмиссией достигается более высокое разрешение и увеличение.
Добавляя насадки, такие как детектор рентгеновского излучения для элементного анализа, детектор обратно-рассеянных электронов для наблюдения за составом и EBSD (дифракция обратно-рассеянных электронов) для кристаллического анализа, можно еще больше расширить универсальность измерений.
Различные функции SEM
| Наблюдение вторичного электронного изображения | Вторичные электроны используются для наблюдения за топографией поверхности образца. |
|---|---|
| Наблюдение за изображением обратно рассеянных электронов |
Обратнорассеянные электроны в основном используются для наблюдения за различиями в составе образца. В случае поликристаллического образца различия в ориентации кристаллов наблюдаются как контраст изображения. (канальный контраст) |
| Наблюдение за поглощением электронным изображением | Поглощенные электроны в основном используются для наблюдения за различиями в составе образца. Контраст противоположен контрасту изображения в обратно рассеянных электронах. |
| Наблюдение за трансмиссионным электронным изображением | Электроны, прошедшие через тонкий пленочный слой, используются для наблюдения за различиями в составе и плотности. |
| Наблюдение за изображением катодолюминесценции (КЛ) и анализ спектра | Свет, испускаемый образцом, стимулированным облучением электронным пучком, формирует изображение, а спектр излучения создается с помощью спектрометрии длин волн. Это используется для таких приложений, как оценка примесей и дефектов в полупроводниках, оценка распределения напряжений, оценка распределения структуры дефектов в оксидной пленке, оценка светоизлучающих элементов и т. д. |
| ЭДС(Элементальный)Анализ | Это функция для получения спектра интенсивности энергии рентгеновского излучения с использованием комбинации полупроводникового детектора, легированного лидом, и многоканального анализатора (анализатора спектра). Все элементы от B до U могут быть обнаружены и измерены одновременно. Даже при небольшом токе зонда, снижающем риск повреждения образца, он превосходно работает при анализе микрозон. |
| EBSD-анализ | Обратно рассеянные электроны, которые дифрагировали на поверхности образца, используются для определения ориентации кристалла в микрообласти и для измерения карты ориентации. |
| WDS (элементарный) анализ | Это функция для получения спектра длин волн за счет использования явления дифракции рентгеновских лучей на кристалле. Его особенностями являются высокое энергетическое разрешение и высокая чувствительность обнаружения. |
| Измерение EBIC, наблюдение | Электродвижущая сила (ЭДС), возникающая внутри образца при облучении электронным пучком, используется для анализа дефектов полупроводниковых приборов. |
| Функция низкого вакуума |
Функция установки давления в камере образца от нескольких десятков до нескольких сотен Па. Уменьшение вакуума в камере для образца уменьшает возникновение заряда. Это позволяет наблюдать за непроводящим электричеством образцом без необходимости сложной предварительной обработки (покрытия). Он используется для образцов с большим выделением газов, образцов с низким давлением паров, а также образцов, содержащих воду. |
| Функция воздействия электронным лучом | Возможна резистивная литография электронным лучом. |
| Крио СЭМ наблюдение | Наблюдение за водосодержащим образцом возможно путем замораживания воды. Это может предотвратить возникновение деформации образца в процессах фиксации и обезвоживания. |
| Наблюдение за отоплением |
Возможно наблюдение при нагревании образца. Можно наблюдать изменения, происходящие с образцом под воздействием тепла, такие как набухание и сегрегация примесей. |
| Наблюдение за растяжением | Возможно наблюдение при растяжении образца. Это используется для наблюдения за начальной точкой вязкого разрушения и анализа прочности материала. |
