Аналитические электронные микроскопы
Аналитические электронные микроскопы

Компания JEOL представила первый в мире аналитический электронный микроскоп в 1970 году на 7-й Международной конференции по электронной микроскопии (Гренобль, Франция). С тех пор тысячи устройств использовались в первоклассных университетах и институтах по всему миру. Аналитические электронные микроскопы стали инструментом не только для наблюдения наноразмерных структур, но и для сбора информации о взаимодействии между падающими электронами и атомами образца. В результате область применения электронного микроскопа резко расширилась. На сегодняшний день не существует просвечивающего электронного микроскопа, который нельзя было бы оснастить аналитическими функциями. Они являются ценным инструментом в передовых областях, таких как научные исследования и разработка материалов.
От «Хочу увидеть» к «Хочу понять»
Идея микроскопа, которая родилась из нашего сильного желания ясно видеть мелкие предметы, превратилась из оптического микроскопа в 17 веке в электронный микроскоп. Хотя электронный микроскоп появился всего 50 лет назад, в настоящее время он продвинулся настолько, что можно непосредственно наблюдать наш атомный и молекулярный мир. Наше желание видеть маленькие вещи удовлетворяется до предела.
Однако наше научное желание безгранично; мы стремимся узнать, что существует внутри того, что мы уже видели. Это может быть то же самое желание с самого начала науки; мы эволюционировали, используя наши обоняние, слух, осязание и вкус, чтобы узнавать о вещах, которые мы видим.
Анализ любых данных

рис. 1
Аналитический электронный микроскоп — это просвечивающий электронный микроскоп, оснащенный такими аналитическими функциями, как EDS (энергодисперсионная рентгеновская спектрометрия) и EELS (спектрометрия потерь энергии электронов), позволяющими выполнять качественные и количественные измерения, картирование распределения элементов и анализ химического состояния в смотровые площадки микроразмера.
Когда образец освещается ускоренными электронами, эквивалентными свету оптического микроскопа, происходят различные явления. Как показано на рис.1, генерируются различные сигналы, отражающие характер образца.
Обнаружив вторичные электроны и обратно рассеянные электроны, прибор функционирует как сканирующий электронный микроскоп для наблюдения за формой и структурой поверхности образца. Это позволяет получить изображение с лучшим пространственным разрешением (кратчайшее расстояние между двумя соседними различимыми точками), чем у обычного однофункционального сканирующего электронного микроскопа.
Измеряя интенсивность характеристического рентгеновского излучения, испускаемого образцом, можно определить состав элементов в образце. Этот метод называется EDS и отличается от метода EPMA (рентгеновская спектрометрия с дисперсией по длине волны, используемая в электронно-зондовом микроанализаторе), который исследует длину волны характеристического рентгеновского излучения с помощью дисперсионных элементов.
EDS использует полупроводниковый детектор, в котором литий рассеивается на кремнии. Энергия характеристического рентгеновского излучения, испускаемого образцом, немедленно преобразуется этим детектором в импульс напряжения, соответствующий его интенсивности. Подсчитав количество импульсов каждого размера, можно провести элементный анализ и рассчитать соотношение состава.
Обнаружив трансмиссионные электроны, можно получить не только электронно-микроскопическое изображение высокого разрешения, но также сканирующее трансмиссионное изображение и картину дифракции электронного луча, отражающую кристаллическую структуру.
К трансмиссионным электронам относятся как электроны, возникшие в результате взаимодействия падающих электронов с атомами образца, так и электроны, не подвергшиеся такому взаимодействию. Используя этот факт, мы можем провести элементный анализ и отследить состояние химической связи и расстояние между атомами образца, измеряя интенсивность энергии проходящих электронов. Этот метод называется EELS и считается, наряду с EDS, одной из важных функций аналитических электронных микроскопов.
Особенно хорошо подходит для анализа в микрообластях
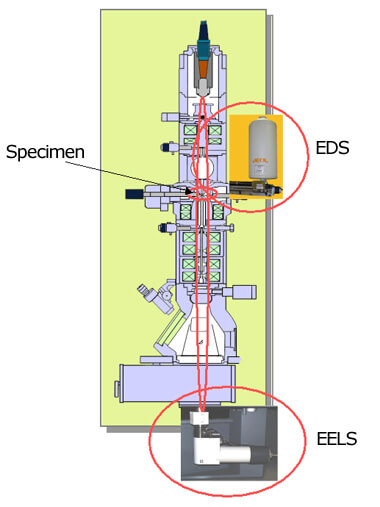
рис. 2
Структура аналитического электронного микроскопа показана на рис. 2.
Добавляя функции сканирующего электронного микроскопа к основному блоку обычного просвечивающего электронного микроскопа, становится возможным наблюдение за поверхностью образца.
Аналитические электронные микроскопы могут использовать различные сигналы для формирования изображений. Одновременно включение EDS и EELS позволяет проводить элементный анализ и наблюдать изображения потерь энергии.
